
 | |
 |
Главная » Мануалы 1 2 3 4 5 ... 20 в полупроводниковой технологии называют кристаллом, а в пленоч ной технологии - платой. / В настоящее время микросхемы выпускают в корпусном и бескорпусном исполнениях. Корпуса герметичны и защищают микросхемы от воздействия окружающей среды. Бескорпусные микросхемы предназначены для работы в составе радиоэлектронных устройств, которые целиком размещаются в герметизируемых объемах. Их покрывают лаком или заливают компаундами для защиты от внешних воздействий. По функциональному назначению микросхемы подразделяются на цифровые и аналоговые. Если микросхема предназначена для преобразования и обработки сигналов, изменяющихся по закону дискретной функции, то она называется цифровой (логической). К аналоговым относятся микросхемы, предназначенные для преобразования и обработки сигналов, изменяющихся по закону непрерывной функции. В частном случае аналоговые микросхемы для преобразования и обработки сигнала, изменяющегося линейно, называют линейными. Показателем сложности микросхемы является степень интеграции К, которая характеризуется числом содержащихся в ней элементов и компонентов N:K=\gN, где К округляется до ближайшего большего целого числа. По степени интеграции микросхемы подразделяют: на малые интегральные схемы (МИС) - это схемы 1...2-Й степени интеграции, содержащие от нескольких до 100 элементов и компонентов, в состав которых входит один или несколько видов функциональных аналоговых или логических элементов, например логических элементов И, ИЛИ, НЕ, триггеров, усилитель, фильтр и т. п.; средние интегральные схемы (СИС) - схемы 2...3-й степени интеграции, содержащие от нескольких десятков до I ООО элементов и компонентов, в состав которых входят один или несколько одинаковых функциональных узлов электронных устройств (регистр, счетчик, дешифратор, постоянное запоминающее устройство); большие интегральные схемы (БИС) - это схемы 3...4-Й степени интеграции, содержащие от нескольких сотен до 10 000 элементов, в состав которых входит одно или несколько функциональных устройств (например, арифметико-логическое устройство, оперативное запоминающее устройство, перепрограммируемое постоянное запоминающее устройство и др.); сверхбольшие интегральные схемы (СБИС) - это интегральные микросхемы 5...7-й степени интеграции, представляющие собой законченное микроэлектронное изделие, способное выполнять функции аппаратуры (например, ЭВМ). Наибольшей степенью интеграции обладают полупроводниковые микросхемы, затем тонкопленочные и, наконец, толстопленочные (в том числе, гибридные). По степени интеграции полупроводниковые микросхемы на биполярных транзисторах уступают интегральным микросхемам на МДП-транзисторах (см. табл. 1.1). Таблица 1.1. Классификация микросхем по уровням интеграции Уровень Число элементов и компонентов в одной микросхеме
По применяемости в аппаратуре различают микросхемы широкого и частного применения. К последним относятся микросхемы, предназначенные для использования в конкретной аппаратуре и изготавливаемые непосредственно на предприятии, ее производящем. В ряде случаев разработчики конкретной РЭА для улучшения показателей ее миниатюризации изготавливают микросборки, в состав которых входят элементы, компоненты, интегральные микросхемы и другие ЭРЭ. Микросборки по технологическому исполнению не отличаются от гибридных микросхем. И по функциональной сложности, и по степени интеграции микросборки, как правило, соответствуют БИС. Однако в отличие от них они не выпускаются как самостоятельные изделия широкого применения, а являются микроэлектронными изделиями частного применения, разрабатываемыми для конкретной МЭА. Характерно, что в состав микросборок могут входить и корпусированные ИС, например из микропроцессорного набора. Корпуса для микросборок могут выбираться из стандартного ряда или проектироваться специально. Бескорпусные микросборки используются в аппаратуре с общей герметизацией аналогично гибридным БИС и создаются по тонкопленочной и толстопленочной технологии с применением ситалловых, поликоро-вых, многослойных керамических и металлических эмалированных подложек. В ряде случаев разработка микросборок диктуется необходимостью обеспечения хорошего теплоотвода. Классификация ИС по конструктивно-технологическому исполнению на полупроводниковые, пленочные и гибридные, по принципу работы активных элементов на МДП-микросхемы и микросхемы на биполярных транзисторах, по виду обрабатываемой информации на цифровые и аналоговые не исчерпывает всего многообразия признаков, необходимых для описания их в практической деятельности разработчиков, конструкторов и технологов РЭА. Так, цифровые микросхемы можно подразделить по функциональному назначению на подгруппы логических и интегральных схем запоминаюш,их устройств (ЗУ). Они имеют различия в конструктивном исполнении. Однако это деление, еще широко используемое в 6о-5о- -оВыход  Рис I 17. Малая микросхема ТТЛ-типа - двухвходовый вентиль И - НЕ: о-схема электрическая принципиальная; б-чертеж топологии микросхемы с фигурами совмещения, тестовыми резистором н транзистором < г 3;8 о-  Рис. 1.18. Малая микросхема ЭСЛ-типа - трехвходовый вентиль ИЛИ - НЕ: о -схема электрическая принципиальная; б - топология Ин 6 h:i U2 Hi Рис. 1.19. Вертикальная структура (о) и электрическаи схема (б) типового И Л-элемеита практике, оказывается условным: появились микропроцессорные БИС, СБИС однокристальных ЭВМ, в которых на одном кристалле размещены и изготовлены как логические, так и запоминающие устройства. Широкое развитие цифровых методов обработки сигналов привело к созданию БИС, предназначенных для связи цифровых и аналоговых устройств - аналого-цифровых преобразователей (АЦП) и цифро-аналоговых преобразователей (ЦАП). Логические микросхемы на основе биполярных транзисторов по схемотехническому и конструктивно-технологическому исполнению разделяют на типы: резисторно-транзисторные логические (РТЛ) и их модификации (с непосредственными связями, с емкостными связями и т. д.); транзисторно-транзисторные логические (ТТЛ) и их модификации (ТТЛ с диодами Шотки и др.) (рис. 1.17); эмиттер-но-связанные логические (ЭСЛ) (рис. 1.18); интегральные инжек-ционные логические (И^Л) (рис. 1.19); инжекционно-полевые логические (ИПЛ). Логические микросхемы на МДП-транзисторах подразделяют на: р-канальные (р-МДП) (рис. 1.20); /г-канальные (/г-МДП); комплементарные на взаимодополняющих п- и р-канальных транзисторах (КМДП) (рис. 1.21). В настоящее время промышленность выпускает множество серий логических интегральных микросхем, и разработчику аппаратуры необходимо уметь проводить сравнительный анализ по их характеристикам, чтобы найти наилучшие соотношения характеристик в. соответствии с требованиями к разрабатываемым микроэлектронным изделиям. Этими характеристиками являются: быстродействие (задержка переключения), потребляемая мощность, произведение мощности на время задержки, запас помехоустойчивости, коэффициент разветвления по выходу, требования к напряжению питания, диапазон рабочих температур, плотность размещения элементов на -£ т Т2\ w\ Выход  Рис. 1.20. Фрагмент микросхемы трехвходового вентиля ИЛИ-НЕ на р-каиаль- ных МДП-транзисторах: а-схема электрическая принципиальная; б - топология  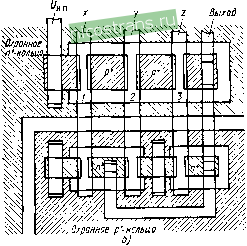 Рис. 1.21. Фрагмент микросхемы трехвходового элемента ИЛИ - НЕ на р-канальных МДП-транзисторах: а - схема электрическая принципиальная; б - топология Таблица 1.2. Сводка ориентировочиых значений рабочих параметров элементов цифровых логических микросхем (1980 г.)
кристалле, степень интеграции, стоимость и др. Сведения об этих характеристиках приведены в табл. 1.2. Трудности выбора усугубляются тем, что технология производства многих типов логических схем продолжает развиваться, и разработчики аппаратуры должны уметь предвидеть, какая ситуация может сложиться через несколько лет. Наибольшим быстродействием обладают микросхемы ЭСЛ-типа. Однако им присущи самая высокая потребляемая мощность и стоимость, так как они занимают большую площадь кристалла и имеют более сложную электрическую схему. Этим схемам отдают предпочтение в аппаратуре, в которой требуется наибольшее быстродействие любой ценой. ЭСЛ-микросхемы сохраняют работоспособность в большом интервале температур и при колебаниях напряжения в цепях питания. Большая потребляемая мощность затрудняет получение ЭСЛ-микросхем высокой степени интеграции, так как тепловая мощность, отводимая от кристалла, не может превышать нескольких ватт. (Чтобы ощутить тепловой поток от единицы поверхности кристалла, рассеивающего такую энергию, надо сравнить его с тепловым потоком с единицы поверхности электрической лампы мощностью 500 Вт.) Поэтому ЭСЛ-микросхемы - это обычно МИС или СИС (см. табл. 1.1). При создании аппаратуры на ЭСЛ-микро-схемах требуется значительная площадь коммутационных плат и, соответственно, большая длина соединяющих их проводников, что влечет за собой искажение формы сигналов и требует установки соответствующих нагрузок на концах линий связи. Недостатком схем ЭСЛ является и то, что для их работы необходимы два источника питания. Для сравнения различных типов микросхем используют такой параметр, как произведение задержки переключения на мощность. Чем меньше это произведение, тем предпочтительнее данный тип микросхем, так как то же самое время задержки (быстродействие) получают при меньшей мощности. Однако чем меньше произведение задержки на мощность, тем более чувствительны микросхемы к выходной нагрузке. В связи с этим микросхемы типа ЭСЛ и ТТЛ с большой потребляемой мощностью (см. табл. 1.2) малочувствительны к выходной нагрузке. Схемы ТТЛ менее дорогие, чем ЭСЛ, и обладают несколько меньшим быстродействием, хотя и превосходят по быстродействию остальные биполярные микросхемы. Но здесь при сравнении должна учитываться степень интеграции. Если степень интеграции ЭСЛ-схем мала, то для изготовления одного и того же устройства таких схем потребуется больше, чем схем ТТЛ, обладающих большей степенью интеграции. То быстродействие, которое выигрывается при использовании ЭСЛ-схем, может быть потеряно в соединяющих их проводниках. Особенностями схем интегральной инжекционной логики являются малое значение произведения времени задержки на мощность, малая площадь, занимаемая одним логическим И^Л-элeмeнтoм на кристалле, и технологическая совместимость И^Л-элементов с другими типами биполярных логических схем: они могут быть изготовлены в одном кристалле вместе с ЭСЛ- и ТТЛ-схемами. Для микроэлектронных устройств с автономными источниками питания (наручные часы, электронные игрушки и др.) целесообразно использовать И^Л-схемы или МДП-схемы, потребляющие намного меньшую мощность, чем рассмотренные выше схемы, и имеющие сравнительно низкую стоимость. В связи с тем, что р-, п-МДП-и КМДП-схемы потребляют малую мощность и их элементы занимают малую площадь на кристалле, они более всего подходят для создания БИС и СБИС. Схемы КМДП обладают наименьшим потреблением энергии и наибольшей помехозащищенностью. При разработках микроэлектронной аппаратуры целесообразно применение микросхем полупроводниковой памяти, которые могут быть использованы для хранения программ, а также для замены некоторых логических схем. Микросхемы полупроводниковой памяти - запоминающие устройства (ЗУ) - в настоящее время выполняются в виде СБИС. Они либо входят в состав микропроцессорных комплектов, либо выпускаются в виде автономных СБИС, предназначенных для использования в аппаратуре. Их можно классифицировать по ряду независимых признаков: способу хранения информации; способу обращения к памяти; принадлежности к подсистемам памяти ЭВМ; типу носителя информации; функциональному назначению; схемно-технологическому исполнению и т. д. По способу хранения информации ЗУ делятся на статические, динамические и квазистатические. В статических ЗУ хранение информации обеспечивается с помощью постоянного источника питания, информация в режиме хранения неподвижна относительно массива ячеек (носителя информации), при отключении источника питания информация разрушается. В динамических ЗУ информация хранится в виде зарядов, для чего используются емкости р-п переходов и МДП-структур. Время хранения информации ограничено, вследствие чего необходимо периодически ее восстанавливать. По способу обращения к информации различают адресные, ассоциативные ЗУ и ЗУ с произвольной выборкой (ЗУПВ). По функциональному назначению ЗУ делятся на постоянные, логические и оперативные. Постоянные ЗУ (ПЗУ) служат для хранения констант и программ. Основными требованиями к ним являются: неразрушающее считывание, высокая надежность, энергонезависимость хранения информации. Различают ПЗУ, программируемые при изготовлении, в которых информация заносится один раз в конструкцию запоминающего массива ячеек и не подвергается изменению, 1ПЗУ - однократно программируемые ПЗУ и РПЗУ - многократно репрограммируемые ПЗУ, в которых запись информации осуществляется пользователем этих интегральных схем памяти. Особую разновидность элементов памяти представляют программируемые логические устройства (ПЛУ), в которых на одном кристалле сформированы логические элементы одного типа. Созданием системы соединений этих элементов (программирования) обеспечивается функционирование ПЛУ. Таким образом, ПЛУ функционально сходны с ПЗУ, запись программ в ПЛУ технологически осуществляется так же, как и программирование ПЗУ, пережиганием перемычек в металлизации, фотошаблоном для формирования контактных окон и др. Практически все типы микросхем памяти могут быть построены на биполярных и на МДП-структурах, что обеспечивает широкий набор их характеристик. Аналоговые микросхемы по выполняемым функциям представляют собой очень широкий класс устройств различного назначения: дифференциальные и операционные усилители, широкополосные усилители, усилители мощности, аналоговые умножители и модуляторы, цифро-аналоговые и аналого-цифровые преобразователи, частотно-избирательные устройства. Номенклатура выпускаемых аналоговых микросхем очень широка. В ряде случаев цифровые БИС и СБИС микропроцессорных наборов содержат в своей структуре и аналоговые блоки. Создание БИС позволило значительно повысить функциональную сложность микросхем, что привело к уменьшению их универсальности, а следовательно, к неизбежному увеличению их номенклатуры. Возникла противоречивая, чуть ли не парадоксальная ситуация: чем выше технологический уровень производства, тем более сложные в конструктивном и функциональном отношении микросхемы можно изготовить, но чем выше их степень интеграции, тем более специализированными они становятся и тем большее количество различных сложных устройств надо изготовить в виде интегральных микросхем для создания различных видов микроэлектронной аппаратуры. При этом, естественно, объемы производства каждого устройства будут сравнительно небольшими. Но уже одна только разработка БИС и СБИС занимает несколько месяцев, а ее освоение в производстве - до нескольких лет. Качественным скачком, определившим выход из противоречивой ситуации, явилось создание БИС, функции которых могли быть заданы подачей по определенной программе на их входы внешних электрических импульсов. Возможность функциональной перестройки с помощью программирования является отличительной чертой интегральных схем микропроцессоров. Появление микропроцессорных БИС и СБИС является результатом поступательного развития и взаимного обогащения технологии микроэлектроники и микросхемотехники (высокая степень интеграции, создание схемотехнически сложных устройств в одном кристалле) и вычислительной техники (развитие архитектуры .ЭВМ, алгоритмических языков и программного обеспечения). Как известно, процессор-это основная часть ЭВМ, непосредственно осуществляющая процесс обработки данных и управляющая им. Микропроцессором (МП) называется программно-управляемое устройство, осуществляющее обработку цифровой информации и построенное на одной или нескольких СИС, БИС или СБИС. Микропроцессорный комплект микросхем (МПК) - это набор микросхем, предназначенных для совместного применения, включающий необходимое и достаточное их количество для построения вычислительной техники. Базовым микропроцессорным комплектом называется минимальный набор интегральных микросхем, необходимый и достаточный для построения микропроцессора. Микросхема, предназначенная для построения различных узлов и устройств ЭВМ или микро-ЭВМ и входящая в состав микропроцессорного комплекта, называется микропроцессорной интегральной микросхемой. Как вычислительные устройства микропроцессоры характеризуются простотой управления, малым потреблением энергии, неболь-щими габаритными размерами, возможностью встраивания в объект контроля или управления, возможностью адресации к большим объемам памяти, а как изделия электронной техники - конструктивно-технологическим исполнением, степенью интеграции, надежностью, стоимостью, способом защиты от внешних воздействий. В табл. 1.3 приведен перечень выпускаемых промышленностью и широко используемых микропроцессорных комплектов, из которой видно, что большинство из них выпускаются с использованием Таблицу 1.3. Микропроцессорные комплекты БИС и СИС
Совместная разработка ГДР и СССР [Н]. различных вариантов МДП-технологии. По технологии изготовления, базирующейся на биполярных транзисторах (И^Л, ТТЛ, ТТЛШ), выпускают секционированные микропроцессоры, с наращиваемой разрядностью обрабатываемых чисел: 2п, 4п, 8п и т. д., где /г= 1 2 3, ... Микропроцессорные БИС и СБИС являются типичными представителями программно-перестраиваемых интегральных микросхем. Вторым путем сокращения номенклатуры БИС является построение БИС на основе базового кристалла, представляющего собой матрицу не соединенных между собою элементов, электрические связи между которыми формируются в соответствии с назначением БИС на этапе формирования разводки групповым способом с помощью одного или нескольких заказных фотошаблонов. Такие БИС называются матричными или (иногда) полузаказными. На основе одного базового кристалла можно изготовить сотни функционально различных устройств. Весь процесс разработки матричной БИС от составления технического задания до получения опытных образцов занимает несколько Недель. Применение системы автоматического проектирования (САПР) позволяет еще больше сократить цикл разработки и подготовки производства матричных БИС. Функциональные элементы матричных БИС выбирают исходя из технологии изготовления базового кристалла и схемотехнического базиса. Наиболее часто при использовании биполярных транзисторов используют ЭСЛ, ТТЛ, ТТЛШ и И^Л базисы, а при использовании МДП-транзисторов - п-канальные и КМДП-устройства. Набор элементов, входящих в библиотеку матричной БИС, содержит как отдельные элементы или простые логические ячейки типа И-НЕ; ИЛИ-НЕ, так и достаточно сложные узлы, широко используемые в аппаратуре, например различные триггеры, регистры, счетчики, дешифраторы, мультиплексоры, усилители и т. п. 1r5 Шв - X R3 о 1 1  J Общий а) Рис. 1,22. Электрическая Схема и топология ячейки ТТЛ матричной БИС На рис. 1.22, а, б показан набор элементов типовой ячейки ТТЛ-матрицы и компоновка этих элементов в базовом кристалле, выполненная с учетом минимизации занимаемой площади. Для удобства трассировки межэлементных соединений как внутри ячейки, так и между ячейками, элементы и контактные площадки имеют унифицированные размеры и регулярное расположение. В качестве примера укажем, что отечественной промышленностью выпускаются быстродействующие ЭСЛ матричные БИС серий К1520ХМ1 и К1520ХМ2. Глава 2. КОНСТРУКЦИИ ЭЛЕМЕНТОВ ПОЛУПРОВОДНИКОВЫХ МИКРОСХЕМ НА БИПОЛЯРНЫХ ТРАНЗИСТОРАХ 2.1. ПРИНЦИП ДЕЙСТВИЯ БИПОЛЯРНОГО ТРАНЗИСТОРА Название транзистора - биполярный - означает, что в физических процессах, проходящих в этом полупроводниковом приборе, участвуют как электроны, так и дырки. Движение носителей заряда может быть вызвано двумя причинами: наличием градиента концентрации носителей или наличием градиента электрического потенциала. В первом случае возникает диффузия носителей, во втором - дрейф носителей в электрическом поле. Если действуют обе причины, то полный ток носителей состоит из диффузионной и дрейфовой составляющих. В полупроводнике р-типа основные носители - дырки, в полупроводнике п-типа - электроны. И в электронный, и в дырочный полупроводник могут быть тем или иным способом введены неосновные носители. Процесс введения неосновных носителей называется инжекцией. Предположим для определенности, что в поверхностный слой дырочного полупроводника осуществляется инжекция электронов. Инжектированные электроны благодаря градиенту концентрации начнут диффундировать с поверхности в объем полупроводника. В нем появится электронный ток. Избыточный заряд неосновных носителей - электронов - будет немедленно компенсирован таким же зарядом дырок, притягиваемых к поверхности из глубины полупроводника. Если инжекция неосновных носителей осуществляется постоянно под действием внешнего электрического поля, возникнут потоки электронов и дырок, направленные в разные стороны. Неосновные носители - электроны - будут двигаться в глубь полупроводника, а основные носители - дырки - в сторону инжектирующей поверхности, вблизи которой происходит интенсивная ре- Рис. 2.1. Вертикальная структура интегрального пла-нарно-эпитаксиаль-ного транзистора п^-р-п-типа ПоВложна и изоляции Еаза Эмиттер Ноллентор  комбинация дырок с электронами. Полный ток в цепи - величина постоянная, поэтому его электронная и дырочная составляющая меняются в разные стороны: с удалением от поверхности электронный ток убывает (из-за рекомбинации), а дырочный ток растет. Вдали от поверхности дырочная составляющая - главная и имеет чисто дрейфовый характер (дырки двигаются в поле, созданном внешним напряжением); наоборот, в непосредственной близости к поверхности ток почти чисто электронный и обусловлен диффузией электронов. При инжекции электронов в неоднородно легированный полупроводник с внутренним электрическим полем, их диффузия будет сочетаться с дрейфом под действием этого поля. Так как легирование кремниевой пластины донорными или акцепторными примесями при изготовлении микросхем осуществляется с рабочей стороны поверхности, то в полупроводниковых слоях всегда имеется градиент концентрации примеси и движение в них носителей тока является комбинированным. Вертикальная структура интегрального биполярного транзистора (см. рис. 1.12) показана на рис: 2.1. Этот транзистор изготовлен по планарно-эпитаксиальной технологии, оба р-п перехода получены диффузией примесей (вначале акцепторной в эпитаксиальный слой /г-типа, затем донорной в только что сформированную область /7-типа). В процессе первой диффузии формируется базовая область транзистора, р-п переход база - коллектор (коллекторный) и р-п переход эмиттер - база (эмиттерный). Рабочей (активной) областью транзистора называется область, расположенная под донной частью эмиттера (на рис. 2.1 она заштрихована). Остальные области транзистора являются пассивными, т. е. в какой-то мере паразитными. Их наличие обусловлено конструктивно-технологическими причинами. Вырежем под контактом к эмиттеру брусочек материала (см. пунктир на рис. 2.1) и рассмотрим процессы, протекающие в нем при включении транзистора по схеме с общей базой (рис. 2.2). На этом рисунке буквой w обозначена ширина базовой области транзистора, а резисторы Гб и Гк имитируют пассивные области базы и коллектора. Эмиттерный и коллекторный переходы транзистора не являются независимыми. Взаимодействие между ними обеспечивается малой 2 Зак. 918 - о + 9 -о 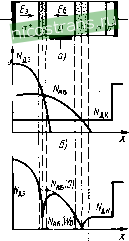 1/7 Щ i>4 Про(О) г) Рис. 2.2. Нормальное включение rtt-p-rt-траизисто-ра, работающего в активном режиме Рнс. 2.3. Структура планарно-эпитаксиального + -р-п-транзистора (а) распределение концентраций (б) н результирующее распределение (в) активных примесей, распределение основных и неосновных носителей заряда в отсутствии внешнего электрического поля Точки - обедненные области р-п переходов, стрелки - направление вектора напряженности внутреннего электрического поля шириной базы. У современных транзисторов ш<1 мкм, теоретически минимальное значение w может быть равным 0,03...0,05 мкм. Диффузионная длина носителей тока гораздо больше ширины базы и составляет 5... 10 мкм. Основные свойства транзистора определяются процессами в базе. Если база легирована активной примесью однородно, то движение носителей в ней чисто диффузионное. Если же в базе имеется градиент концентрации примеси, то в ней есть внутреннее электрическое поле и тогда движение носителей в ней будет комбинированным. Транзисторы с однородной базой называют бездрейфовыми, с неоднородной - дрейфовыми. Дрейфовые транзисторы имеют в полупроводниковых микросхемах наибольшее распространение. Распределение концентрации атомов донорной примеси в эмиттере Мд,э И коллекторе Л^дк и атомов акцепторной примеси в базе Маб В областях дрейфового транзистора (рис. 2.3, а) показано на рис. 2.3, б, модуль суммарного распределения Л^д-iVal - на рис. 2.3, в. Распределение основных и неосновных носителей заряда в этих областях в условиях равновесия дано на рис. 2.3, г. При нормальном включении транзистора на эмиттерном переходе действует прямое напряжение, а на коллекторном - обратное (см. рис. 2.2, 2.3, а). При этом электроны инжектируются из эмиттера в базу, проходят через нее почти без потерь (потери электронов на рекомбинацию невелики, так как ширина базы мала) и попадают в коллектор, находящийся под положительным потенциалом. Коллектор собирает электроны, поступившие из эмиттера в базу. Чтобы третий, изолирующий р-п переход транзистора был смещен в обратном направлении, кремниевая подложка р-типа присоединяется к точке схемы, имеющей наибольший отрицательный потенциал (см. рис. 2.1). В нормальном включении токи коллектора и эмиттера почти одинаковы с точностью до незначительного тока базы (см. рис. 2.2). Последний компенсирует убыль основных носителей (дырок) в результате рекомбинации (хоть и незначительной, но все же отличной от нуля), а также небольшие потери дырок из области базы из-за их инжекции в область эмиттера. Сопротивление обратносмещенного коллекторного перехода велико- несколько мегаом. Поэтому в цепь коллектора можно включать большие сопротивления нагрузки, не изменяя величины коллекторного тока и обеспечивая в цепи нагрузки выделение значительной мощности. Сопротивление прямосмещенного эмиттерного перехода, наоборот, довольно мало (от единиц до нескольких десятков ом). Поэтому при почти одинаковых токах мощность, потребляемая в цепи эмиттера, оказывается намного меньше чем мощность, выделяемая в цепи нагрузки. Следовательно, транзистор способен усиливать мощность, т. е. он является усилительным прибором. В транзисторных схемах один вывод прибора обычно используется для входного сигнала, другой - для выходного. Третий вывод - общий для входного и выходного сигнала. Из шести возможных вариантов включения только три дают увеличение полезной мощности. Это уже рассмотренная схема с общим эмиттером (см. рис. 2.2), а также схемы с общей базой и общим коллектором. Каждый из этих вариантов имеет свой набор положительных качеств и недостатков. Выбор того или иного варианта зависит от требуемых значений входного и выходного сопротивлений, коэффициентов усиления по току и напряжению. Схема с общей базой позволяет наглядно рассмотреть работу транзистора, физическую природу проходящих в нем процессов. Однако она обладает малым входным сопротивлением, равным сопротивлению эмиттерного перехода, и не обеспечивает усиления тока, что делает ее не очень удобной для большинства применений. Часто используется другой вариант включения - с общим эмиттером, для которого характерна заданная величина тока базы. В принципе эмиттер и коллектор в схемных включениях транзистора можно поменять местами: на коллекторный переход задать прямое напряжение, а на эмиттерный - обратное. Такой режим работы называют инверсным включением. Передача тока при инверс- ном включении значительно хуже, чем при нормальном по следующим причинам; концентрация активных примесей в коллекторе на несколько порядков меньше, чем в эмиттере, из-за чего электронная составляющая коллекторного тока мала; площадь эмиттера меньше площади коллектора и на нее может попасть только часть электронов, инжектируемых коллектором. Нормальное и инверсное включение обеспечивают активный режим работы транзистора как усилительного прибора. Возможны еще два варианта включения: при прямом смещении и эмиттерного и коллекторного р-п перехода транзистор будет работать в режиме насыщения; при подаче обратного смещения и на эмиттерный и на коллекторный переход транзистор будет работать в режиме запирания (отсечки). В интегральных микросхемах используются и транзисторы, у которых эмиттер и коллектор имеют дырочную проводимость, а база - электронную. Их называют р-п-р-транзисторами. Естественно, что они имеют другие полярности рабочих напряжений. Неосновными носителями в базовой области этих транзисторов будут дырки, подвижность которых в 2...3 раза меньше подвижности электронов. Поэтому быстродействие и ряд других характеристик таких транзисторов хуже, чем у п-р-п-транзисторов. Однако наличие р-п-р-транзисторов в полупроводниковых микросхемах наряду с п-р- -транзисторами дает дополнительные возможности для улучшения характеристик микросхем. В качестве примера можно указать на наличие горизонтального р-п-р- и вертикального п-р-п-транзисторов в схемах интегрально инжекционной логики (см. рис. 1.19). Транзисторы п-р-п и р-п-р- типа, употребляющиеся совместно в интегральных микросхемах, называют комплементарными (взаимодополняющими). 2.2. КОНСТРУКТИВНО-ТЕХНОЛОГИЧЕСКИЕ ОСОБЕННОСТИ И ВАРИАНТЫ ИНТЕГРАЛЬНЫХ БИПОЛЯРНЫХ ТРАНЗИСТОРОВ, ВЫПОЛНЕННЫХ ПО ПЛАНАРНО-ЭПИТАКСИАЛЬНОЙ ТЕХНОЛОГИИ Транзисторы типа п-р-п. Биполярный транзистор п-р-п-ти-па является ключевым схемным элементом полупроводниковых микросхем. Он обладает лучшими характеристиками, чем транзистор р-п-р-типа, а технология его изготовления более проста. Остальные элементы микросхемы выбираются и конструируются таким образом, чтобы они совмещались с основной структурой. Их изготавливают одновременно с созданием п-р-п-транзистора на основе какой-либо из его областей. Таким образом, выбор физической структуры транзистора однозначно определяет основные электрические параметры микросхемы. Самое широкое распространение получила транзисторная л+-р-п-структура со скрытым подколлекторным п+-слоем (см. рис. 1.12 и рис. 2.1). Следует обратить внимание на то, что вывод коллектора интегрального транзистора расположен на поверхности прибора. Это ведет к увеличению сопротивления тела коллектора и ухудшает характеристики транзистора как в усилительном (частотную), так и в переключающем (уменьшает эффективность переключателя в режиме насыщения) режимах. Увеличение степени легирования всего объема коллекторной области и уменьшение ее удельного сопротивления снижает пробивное напряжение перехода коллектор - база и увеличивает емкость этого перехода, т. е. тоже ухудшает характеристики транзистора. Компромиссным решением проблемы является создание скрытого высоколегированного п+-слоя на границе коллектора и подложки. Этот слой обеспечивает низко-омный путь току от активной коллекторной зоны к коллекторному контакту, не снижая величины пробивного напряжения перехода коллектор - база. Конструктивно этот слой располагается непосредственно под всей базовой областью и простирается вплоть до дальней от базы стороны коллекторного контакта. Толщина этого слоя составляет 2,5...10 мкм, типичные значения ps=10...30 Ом/П. Рабочая зона транзистора начинается непоредственно под эмиттерной зоной (см. рис. 2.1). Для обеспечения необходимого коллекторного тока при минимальном последовательном падении напряжения коллекторный контакт располагают как можно ближе к эмиттерному. Минимальные значения горизонтальных размеров прибора определяются двумя основными технологическими факторами: минимально достижимыми при фотолитографии размерами окон в окисле и зазоров между окнами и глубиной боковой диффузии примеси под окисел. Поэтому при проектировании транзистора надо учесть, что расстояние между базовой областью и коллекторным контактом должно быть значительно больше суммы размеров боковой диффузии р-базы и п+-области под коллекторным контактом. Назначение этой п -области состоит в обеспечении надежного формирования невыпрямляющего алюминиевого контакта к слаболегированной п-области коллектора, поскольку алюминий является акцепторной примесью в кремнии с пределом растворимости около 10 атомов/см. Уровень же легирования эпитаксиального слоя п-типа, составляющего тело коллектора, равен 10...10* атомов/см. Он диктуется, как уже сказано, необходимостью увеличить напряжение пробоя перехода коллектор - база. Расстояния между изолирующей областью р-типа и элементами транзистора определяются также эффектом боковой диффузии. Они должны быть равны примерно толщине эпитаксиального слоя, которая составляет обычно 3,5... 12 мкм. Две типичных конфигурации интегральных транзисторов показаны на рис. 2.4. Для асимметричной конфигурации характерно то, что коллекторный ток в ней протекает к эмиттеру только в одном направлении. При симметричной конфигурации коллекторный ток протекает к эмиттеру с трех сторон и сопротивление коллектора 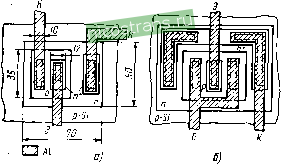 Рнс. 2.4. Топология биполярных интегральных транзисторов для микросхем средней степени интеграции; а - асимметричная; б - симметричная /к = а/э; /к==5/б; В = а/(1 (2.1) (2.2) (2.3) В этих уравнениях а и S - коэффициенты усиления по току в схемах с общей базой и с общим эмиттером соответственно. Для Таблица 2.1. Типичные параметры слоев интегрального п-р-га-транзистора
Примечание. N - концентрация примеси (для диффузионных базового и эмиттерного слоев - поверхностная концентрация); d - толщина слоя; р. - удельное сопротивление материала: р,-удельное сопротивление слоя. оказывается примерно втрое меньше, чем при асимметричной конфигурации. Для конструкции транзистора симметричной конфигурации облегчается разработка топологии металлической разводки, так как в ней оказывается возможным часть коллекторной области разместить под окислом, а поверх окисла над коллектором провести алюминиевую полоску к эмиттерной или базовой области. На рис. 2.4, а даны топологические размеры областей интегрального биполярного транзистора, типичные для микросхем средней степени интеграции. Типичные параметры этих областей приведены в табл. 2.1. В биполярных транзисторах входной управляющей величиной является либо ток базы, либо ток эмиттера, а выходными управляемыми величинами - либо эмиттерный, либо коллекторный токи (см. 2.1). Связь между этими токами записывается в виде следующих уравнений: интегральных транзисторов а=0,99...0,995 при токах порядка нескольких миллиампер В= 100...200 и тем больше, чем а ближе к 1. Величину а можно записать в следующем виде: (2.4) а = -,- = - - = V4, Э 3 Эп где у = эл э=/эп/(/э.+/эр)-коэффициент инжекции, характеризующий долю полезной (для /г-р-л-тразистора электронной 1эп) составляющей в общем токе эмиттера; х = /к эп-коэффициент переноса, характеризующий долю инжектированных носителей, дошедших до коллектора и избежавших рекомбинации. С допустимой точностью Y определяется выражением где W - ширина базы транзистора; - диффузионная длина неосновных носителей в эмиттере; Оь и Dt - коэффициенты диффузии носителей в эмиттерной и базовой областях, легированных до концентраций и Л^б соответственно; у тем ближе к 1, чем меньше величины W и Ne/N-,. Поэтому эмиттерный слой легируют, как можно сильнее. Значения у равны 0,99...0,977 в нормальном токовом режиме и 0,98...0,985 в режиме микротоков. Коэффициент переноса можно представить выражением (2.6) где т-время жизни неосновных носителей в базовой области. Величина х тем ближе к единице, чем меньше ширина базы и больше т. Увеличение времени жизни ухудшает частотные свойства транзистора, поэтому, как следует из (2.5) и (2.6), главным направлением в улучшении характеристик транзисторов является уменьшение ширины базы. Ширина базы в п -р-п-транзисторе, изготовленном по эпитаксиально-планарной технологии, составляет обычно 0,6...0,8 мкм с допустимым отклонением ±0,1 мкм. Коэффициенты усиления тока транзистора зависят от режима его работы (рис. 2.5): при малых значениях тока (10~...10 мА) величина В сравнительно невелика из-за малых значений коэффициента инжекции. Это объясняется рекомбинацией носителей в эмиттерном переходе. Большая доля рекомбинационных потерь приходится на приповерхностные слои. Именно поэтому качество обработки поверхности, пассивация поверхности имеют огромное значение для получения высоких В при малых токах. В области средних и больших токов (> 1 мА, см. рис. 2.5) существенную роль играет эффект вытеснения тока в эмиттере. Напряжение в любой точке эмиттерного перехода представляет собой разность внешнего напряжения б'эв и падения напряжения в объеме базы. Последнее тем выше, чем дальше удалена эта точка  4/2 1  0,001 0,01 0,1 1,0 h,MA Рис. 2.5. Зависимость коэффициента Рис. 2.6. Иллюстрация эффекта от усиления по току В интегральных бипо- теснения эмиттерного тока лярных транзисторов в схеме с общим эмиттером от тока коллектора U ОТ базового контакта (рис. 2.6). Значит, напряжение в центральной части эмиттера меньше напряжения у его краев и край эмиттера приобретает большее прямое смешение, чем середина его плошади, значит, внешние области эмиттера будут работать при больших плотностях тока по сравнению с внутренними. Повышенная плотность тока у краев эмиттера приводит к повышенным рекомбина-ционным потерям носителей в этих областях и к уменьшению В. Топология мошных транзисторов должна обеспечить максимальное отношение периметра эмиттера к его плошади. Например, целесообразно использовать узкие эмиттеры с большим периметром. Изменение конструкции биполярных транзисторов с увеличением их мошности иллюстрируется рис. 2.7...2.9. Коэффициент усиления В уменьшается с понижением температуры (термический коэффициент 5-10~1/°С). Это связано с уменьшением времени жизни неосновных носителей т (см. уравнение 2.6). Рис. 2.7. Фрагмент топологии микросхемы с биполярными транзисторами малой мощности: VD1-диод (транзистор в диодном включении); ~ тестовый транзистор: Vr2 ~ транзистор; R1, R2-диффузионные резисторы; / - контактное окно к диффузионным резисторам; 2-р-область разделительной диффузии; 3...5 - контуры контактных окон к соответственно коллектору, базе, эмиттеру; 6 ... 8-контуры областей соответственно коллектора, базы, эмиттера; 9- пассивирующий слой; W-проводники; -двуокись кремнии  в В А-А    Рис. 2.8. Фрагмент топологии микросхемы с транзистором средней мощности: V£)/.Vfl5 -диоды; vr; - транзистор; i ... 3- контуры областей соответственно коллектора, базы, эмиттера; 4 ... 6-контуры контактных окон соответственно к коллектору, базе, эмиттеру; 7- контур п^-областей коллектора; 8- приваренный к контактной площадке золотой гибкий проводник; 9-контактное окно резистора; 10-р-область разделительной диффузии; пассивирую щийсл ой; /2- Проводники; 13- двуокись кремния    Рис. 2.9. Интегральный биполярный транзистор повышенной мощности гребенчатой конструкции; кремний поликристаллическин; 2- контур га-слоя к коллектору; 3- контур окна к коллектору; 4- контур базы; 5- контур эмиттера; б- контур окна к базе; 7- контур окна к эмиттеру; в-диэлектрик (SiOj); /( -проводник коллектора Структура интегрального транзистора характеризуется еще значениями пробивного напряжения двух р-п переходов: эмиттерного и коллекторного. Если концентрация примесей на обеих сторонах р-п перехода в кремниевых транзисторах меньше 10 атомов/см, то при обратном смещении перехода напряжение пробоя определяется началом лавинного умножения. Это происходит, когда в обедненной области электрическое поле достигает такой величины, когда свободные носители приобретают энергию, достаточную для выбива ния дополнительных вторичных электронов, те в свою очередь генерируют дополнительные электроны и т. д., что приводит к лавинному увеличению числа свободных носителей. Напряжение лавинного пробоя может быть определено из графика на рис. 2.10 по данным о величине концентрации примеси на слаболегированной стороне р-п перехода. 1 2 3 4 5 ... 20 |
||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||