
 | |
 |
Главная » Мануалы 1 2 3 4 5 6 ... 20 10 -  Геория \ N, moMoS/cM Рис. 2.10. Зависимость напряжения лавян-ного пробоя от концентрация примеси на слаболегироваиной стороне ступенчатого р-п перехода , Значения (/ р для переходов эпитаксиально-планарного м-р-п-транзистора даны в табл. 2.2. Из этой таблицы видно, что пробивное напряжение эмиттерного перехода в 5...7 раз меньше коллекторного, так как последний сформирован кэо /кБо/+т: (2.7) где т для п-р-п-транзистора равно 3...4. Пробой может иметь место в результате сужения базы по мере роста коллекторного напряжения из-за увеличения ширины обедненного слоя перехода (прокол базы). Если обедненная область коллекторного перехода расширится настолько, что переходы транзистора сомкнутся, обеспечивается беспрепятственное прохождение тока между коллектором и эмиттером. Такой вид пробоя свойствен транзисторам с особо тонкой базой. Например, при Л/б= = 10® атомов/см, ш=0,7 мкм прокол базы наступает при 7пр=3,5 В. Характеристики транзистора зависят от частоты сигнала. Эти зависимости различны для разных схем включения транзистора, зависят от физической структуры транзистора, наличия в ней паразитных элементов. Частота /т, на которой коэффициент передачи ПО току в схеме с обш,им эмиттером уменьшается до единицы и транзистор теряет усилительные свойства, называется предельной частотой коэффициента усиления тока. Другим показателем, харак- Т а блиц а 2.2. Типичные параметры интегральных п-р-п транзисторов
менее легированными слоями. Для обозначения напряжения пробоя i7np переходов используются три подстрочных индекса (Ук;бо и Иэъо причем последний символ нуль указывает, что при измерении Uap цепь третьего вывода разомкнута. Напряжение пробоя коллектор - эмиттер i/кэо меньше i/кБо и может быть оценено по формуле теризуюшим высокочастотные свойства транзистора, является максимальная частота генерации fmax, при которой усиление по мощности падает до единицы. Они связаны соотношением ... = 4[/т/(8лГбСк)] (2.8) где Гб Ск - постоянная времени базы транзистора, ограничивающая предельное быстродействие транзистора; s - ширина эмиттера. Для интегральных п-р- -транзисторов /т и fmax приблизительно равны 400 и 900 мГц. Из-за того, что подвижность электронов в полупроводниковом материале существенно выше подвижности дырок, п-р-п-транзисторы имеют более высокую предельную частоту коэффициента усиления, чем р-п-р-транзисторы. Транзисторы с тонкой базой обладают повышенными значениями коэффициента усиления В и необходимы для создания ряда аналоговых микросхем (входные каскады операционных усилителей). У этих транзисторов ш=0,2...0,3 мкм; 6=2000.,.5000 при /к=20 мкА, {730=0,5 В. Пробивное напряжение коллектор - эмиттер 1,5...2 В. Многоэмиттерные транзисторы (МЭТ). Структура МЭТ, широко используемых в цифровых микросхемах ТТЛ, приведена на рис. 2.П. Число эмиттеров может быть равным 5...8. МЭТ можно рассматривать как совокупность транзисторов с общими базами и коллекторами. При их конструировании необходимо учитывать следующие обстоятельства. Для подавления работы паразитных горизонтальных п+-р-п+-транзисторов расстояние между краями соседних эмиттеров должно превышать диффузионную длину носителей в базовом слое. Если структура легирована золотом, диффузионная длина не превышает 2...3 мкм и достаточно указанное расстояние сделать равным 10... 15 мкм. Для уменьшения паразитных токов через эмиттеры при инверсном включении МЭТ искусственно увеличивают сопротивление пассивной области базы, удаляя базовый контакт от активной области транзистора, чтобы сопротивление перешейка, соединяющего базовый контакт с базовой областью, было равным 200...300 Ом. А-л  Рис. 2.11. Фрагмент топологии микросхемы с многоэмиттерным транзистором: VDI - диод; VT1 - многоэмиттерный транзистор; 1 ... контуры областей соответственно кол лектора, базы, эмиттера; 4 ... 6- контуры контактны;; окон соответственно к коллектору, базе, эмиттеру; 7- контур п-области коллектора; 8- контур скрытого слоя; 9- р-область разделительной диффузии  Многоколлекторные транзисторы (MKT) - это практически МЭТ, используемые в инверсном режиме: общим эмиттером является эпитаксиальный слой, а коллекторы - -области малых размеров (рис. 2.12). Такая структура является основой микросхем И^Л (см. рис. 1.19). Главная проблема при конструировании MKT- обеспечение достаточно высокого коэффициента передачи тока от общего п-эмиттера к каждому из -коллекторов, поэтому необходимо скрытый -слой расположить как можно ближе к базовому слою и -слои расположить как можно ближе друг к другу. Транзисторы типа р-п-р используются главным образом как нагрузочные приборы для -- -переключательных транзисторов. Все существующие варианты интегральных р- -р-транзисторов существенно уступают -- -транзисторам по коэффициенту усиления и предельной частоте. Для их изготовления используется стандартная технология, оптимизированная для формирования -- -транзистора. Естественно, что получение р- -р-транзис-торов с близкими к теоретическим пределам параметрами в этом случае невозможно. Горизонтальные интегральные р- -р-транзисторы в настоящее время используют наиболее часто (рис. 2.13). Их изготовляют одновременно с -- -транзисторами по обычной технологии. Эмиттерный и коллекторный слои получают на этапе базовой диффузии, причем коллекторный слой охватывает эмиттер со всех сторон. Базовая область формируется на основе эпитаксиального слоя с подлегированием контактной области вовремя эмиттерной диффузии. Перенос носителей в таком р- -/?-транзисторе протекает в горизонтальном направлении. Инжектированные из боковых частей эмиттера в базу дырки диффундируют к коллекторной области. Перенос наиболее эффективен в приповерхностной области, так как здесь расстояние W между коллектором и эмиттером минимальное и наиболее высокая концентрация примеси в р-слоях. Ширину базы W (т. е. расстояние между р-слоями) удается выполнить равной 3...4 мкм (мешает боковая диффузия под маску), в результате  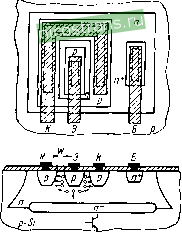 Рис. 2.12. Вертикальная структура многоколлекторного транзистора Рис 2.13. Конструкция горизонтального р-га-р-транзистора чего коэффициент усиления удается получить равным 50, а /т = = 20...40 МГц. Без особого труда получают w равной 6...12 мкм, но при э^гом 6= 1,5...20, а /т только 2...5 МГц. Для уменьшения действия паразитных р- -р-транзисторов (р-эмиттер, -эпитаксиальный слой, р-подложка) стремятся уменьшить площадь донной части эмиттера(его делают возможно более узким), используют скрытый +-слой вдоль границы эпитаксиального слоя и подложки. На основе горизонтального транзистора легко сформировать многоколлекторный р- -р-транзистор. Основные недостатки горизонтального р-п-р-транзистора - сравнительно большая ширина базы и однородность распределения примесей в ней (этот транзистор является бездрейфовым). Эти недостатки можно устранить использованием дрейфовой структуры, в которой два электрода в противоположных концах базы создают в базовом слое электрическое поле, уменьшающее время переноса инжектированных дырок и создающее в эмиттере смещение, снижающее инжекцию из его донной части. Совершенно не изменяя технологический процесс изготовления -- -транзистора, чисто конструктивно и за счет подключения соответствующих областей транзисторной структуры можно сформировать еще один вариант р- -р-транзистора, так называемый подложечный транзистор (рис. 2.14). Поскольку подложка микросхемы обычно подключена к точке схемы, имеющей наибольший отрицательный потенциал, транзистор, показанный на рис. 2.14, можно подключить только по схеме с общим коллектором. По тем же причинам, что и горизонтальные р- -р-транзисторы, подложечный транзистор имеет худшие коэффициент усиления, частотную характеристику. Его база - слаболегированный эпитаксиальный слой - обладает большим сопротивлением и повышенной паразитной емкостью коллекторного перехода из-за значительных его размеров. Составные транзисторы могут быть реализованы на основе двух транзисторов одного или разного типа проводимости, расположенных в одной изолированной области. На рис. 2.15 представлена транзисторная структура, в которой в зависимости от схемы соединений может быть осуществлен составной транзистор, состоящий из двух /г-р- -транзисторов с общим коллектором, или же  п* Эпитаксиальный п-слой Падлатиа р  Рис. 2.14. Вертикальная структура подложечного р-п-р-транзистора Рис. 2.15. Конструкция составного транзистора составной транзистор, состоящий из вертикального п-р-п- и горизонтального р-п-р-транзисторов. В принципе, возможна реализация составных транзисторов в разных изолирующих областях. Составной транзистор имеет коэффициент усиления, равный произведению коэффициентов усиления составляющих его транзисторов: 6=6162, однако быстродействие его определяется наименее быстродействующим транзистором. 2.3. ИНТЕГРАЛЬНЫЕ ДИОДЫ Диоды в микросхемах предназначены либо для того, чтобы выводить транзисторы из насыщения {фиксация транзисторов), либо для выполнения логических функций. Любой из р-п переходов транзисторной структуры может быть использован для формирования диодов, но только два перехода база - эмиттер и база - коллектор действительно удобны для схемных применений. Пять возможных вариантов использования р-п переходов транзистора в качестве диода показаны на рис. 2.16. Параметры интегральных диодов приведены в табл. 2.3. Из анализа таблицы видно, что варианты различаются по электрическим параметрам. Пробивные напряжения U p больше у тех вариантов, в которых используется коллекторный переход. Обратные токи / вр меньше у тех вариантов, в которых используется только эмиттерный переход, имеющий наименьшую площадь. Емкость диода между катодом и анодом Сд у варианта с наибольшей площадью переходов максимальна (Б-ЭК). П;разитная емкость на подложку Со (считается, что подложка заземлена) минимальна у варианта Б-Э. Время восстановления обратного тока 4, характеризующее время переключения диода из открытого в закрытое состояние, минимально у варианта БК-Э, так как у этого варианта заряд накапливается только в базе.    Рис. 2.16. Конструкции интегральных диодов; а - на основе перехода база - Э1 иттер с коллектором, закороченным на базу (БК -Э); 6 - на основе перехода коллектор - база с эмиттером, закороченным на базу (БЭ-К); в -с исполыованнем эмиттерного и коллекторного переходов, когда эмиттерные и коллекторные области соединены (Б -ЭК); г - на основе перехода база - эмиттер с разомкнутой цепью коллектора (Б - Э), д-на основе перехода база - коллектор с разомкнутой цепью эмиттера (Б- К) Таблица 2.3. Типичные иараметры интегральных диодов
Примечание. Для обозначения вариантов диодного включения транзистора приняты следующие сокращения: до черты стоит обозначение анода, после черты - катода; если две области соединены, они пишутся слитно. Оптимальными для микросхем вариантами являются БК-Э и Б-Э, причем чаще используется БК-Э. Пробивные напряжения (7...8 В) достаточны для использования этих вариантов в низковольтных микросхемах. Стабилитроны. Полупроводниковым стабилитроном называют полупроводниковый диод с быстрым нарастанием обратного тока при пробое р-п перехода и нормированным значением пробивного напряжения. Основное назначение стабилитронов - стабилизация напряжения. Интегральные стабилитроны могут быть сформированы на базе структуры интегрального транзистора в различных вариантах в зависимости от необходимого напряжения и его температурного коэффициента. Обратное включение диода Б-Э используют для получения напряжения 5... 10 В с температурным коэффициентом + (2...5) мВ/°С. Диод работает в режиме лавинного пробоя. Обратное включение диода БЭ-К применяют для получения напряжения Рис. 2.17. Вертикальная структура стабилитрона 3...5 В (явление прокола базы, температурная чувствительность - (2...3) мВ/°С). Один или несколько последовательно включенных в прямом направлении диодов БК-Э могут быть использованы как источники напряжения, равного напряжению на открытом переходе (около 0,7 В) или кратного ему. Их температурная чувствительность - 2 мВ/°С. В температурно компенсированном стабилитроне, сформированном на основе базового и эмиттерного (рис. 2.17) слоя, при подаче напряжения между п+-слоями один переход работает в режиме лавинного пробоя, второй - в режиме прямого смещения. Температурная чувствительность напряжения на этих двух переходах имеет противоположный знак, поэтому суммарная температурная чувствительность такдго стабилитрона менее ±2 мВ/°С. 2.4. АКТИВНЫЕ ЭЛЕМЕНТЫ ДЛЯ БЫСТРОДЕЙСТВУЮЩИХ И СВЕРХСКОРОСТНЫХ ИНТЕГРАЛЬНЫХ МИКРОСХЕМ Диоды Шотки. Применение диодов на р-п переходах, например в цепях связи элементов памяти с разрядными шинами в быстродействующих БИС, оказывается недостаточно эффективным из-за сравнительно больших времени их переключения и занимаемой площади. Во многих практически важных случаях предпочтение Отдают диодам Шотки, структура которых представлена на рис. 2.18. Технологические трудности при формировании качественного диодного контакта металл - полупроводник заключаются в необходимости воспроизводимого и контролируемого состояния физических свойств поверхности полупроводника и границы раздела металл - полупроводник, для чего непосредственно перед напылением металлической пленки в условиях вакуума проводится ионно-плазменная очистка поверхности кремния. Диоды с барьером Шотки получают, нанося металл непосредственно на кремний, легированный донорной примесью. При равномерно легированных эпитаксиальных слоях степень легирования должна быть достаточно низкой, чтобы барьер не оказался проницаемым для туннелирующих электронов. На практике концентрация легирующей примеси должна быть меньше Ю'* см. Используют различные высоты барьеров Шотки, получать которые можно, применяя разные металлы и (или) проводя под диод Шотки мелкую п+-ионную имплантацию, понижающую высоту барьера. Алюминий, который чаще всего используется для создания разводки, может также служить для формирования диодов Шотки (с высотой барьера 0,7 эВ), но воспроизводимость их параметров низка. В этом отношении лучшие диоды Шотки получают, применяя сплав платины и никеля NiPti-, образующий силицидный слой при взаимодействии с кремнием. Меняя соотношение между никелем и платиной, можно получать высоты барьера от 0,64 (при 100% Ni) до 0,84 эВ (при 100% Pt). Диоды с гораздо меньшими высотами барьера (соответственно 0,53 и 0,59 эВ) получают при использовании титана и вольфрама. Вторая трудность заключается в возможности возникновения сильных электрических полей на краях контакта металл - полупро- f П  Рис. 2.18. Конструкции планарных диодов Шотки: а - с охранным кольцом; б-с тонким окислом по периферии контакта и расширенным электродом; в-с выводами выпрямляющего и омического контактов на одну сторону подложки; / - металл, образующий с полупроводником п-типа барьер Шотки; 2-металл, образующий с полупроводником п+-тнпа омический контакт водник, приводящих к пробою диода. Для предотвращения пробоя применяют следующие конструктивные меры: формируют по периферии контакта сильно легированную р+-область, так называемое охранное кольцо (рис. 2.18, а), или диэлектрическую прокладку в виде тонкого (около 0,1 мкм) слоя ЗЮг (рис. 2.18, б). В конструкции, представленной на рис. 2.18, в, контакт с барьером Шотки сформирован к п-области полупроводниковой структуры, а омический невыпрямляющий контакт - к п'~-области. Транзисторы с диодами Шотки. Скорость переключения транзисторов, работающих в режиме насыщения, в цифровых схемах ограничена временем рассасывания избыточного объемного заряда, накапливающегося в областях базы и коллектора. Принимаемые для повышения быстродействия транзисторов меры, связанные с ускорением процесса рассасывания (легирование структуры транзистора золотом, шунтирование диодом с р-п переходом) приводят к усложнению технологии, конструкции, снижают другие параметры (например, легирование золотом снижает коэффициент усиления). Изящным решением данной проблемы является сочетание интегрального транзистора с диодом Шотки, который шунтирует коллекторный переход транзистора. На рис. 2.19, а, б приведены две конструкции транзисторов с диодами Шотки. В них алюминиевая Рис. 2.19. Конструкции (a, 6) и принципиальная схема (в) транзисторов с диодами Шотки с охранным кольцом {а) и с расширенным металлическим электродом (б) А-А Г- ---- f-jvn Рис. 2.20. Фрагмент топологии микросхемы, содержащей транзисторы с диодами Шотки: R\, /?2 - диффузионные резисторы: VT\, VT2- транзисторы Шотки; /,.,3 - контуры областей соответственно коллектора, базы, эмиттера; 4,5- контуры контактных окон к коллектору, эмиттеру; б-диод Шотки; 7-граница раздела металл - полупроводник, на которой образуется барьер Шотки  7 о S 5 металлизация, обеспечивая контакт с р-слоем базы, продлена в сторону коллекторного /г-слоя. На первый взгляд, коллекторный слой оказался закороченным на базу. На самом же деле алюминиевый пленочный проводник образует с р-слоем базы невыпрямляю-щий омический контакт, а с /г-слоем коллектора выпрямляющий контакт Шотки (рис. 2.19, в). Конструктивные рещения, показанные на рис. 2.19, а, б, могут быть использованы как в микросхемах, содержащих простые транзисторы (рис. 2.20), так и в микросхемах с многоэмиттерными транзисторами, в которых диоды с р-п переходом заменяются диодами Шотки. В обоих случаях увеличивается степень интеграции микросхем, отсутствует накопление и рассасывание избыточных зарядов и получается существенный (в 1,5...2 раза) выигрыщ во времени переключения транзисторов из открытого в закрытое состояние. Быстродействующие интегральные транзисторы с уменьшенными размерами элементов. Пропорциональное уменьщение геометрических размеров всех областей элементов микросхемы является традиционным направлением увеличения ее быстродействия, что связано прежде всего с уменьщением паразитных емкостей р-п переходов. Первенство по быстродействию сохраняют за собой биполярные п+-р-п-транзисторы, к физической структуре и характеристикам областей которых предъявляются специфичные и одновременно противоречивые требования (§ 2.1): высоколегированный эмиттер с малой глубиной залегания р-/г перехода и больщим градиентом концентрации примеси в области эмиттерного р-п перехода; тонкая активная база с достаточно высокой концентрацией примеси, малым сопротивлением и одновременно сравнительно высокими значениями напряжения пробоя перехода и прокола базы. Минимальный геометрический размер топологии определяется возможностями литографии. В настоящее время осуществляется переход к минимальному проектному геометрическому размеру топологии 1,5...2 мкм (проекционная фотолитография), намечается переход к субмикронным (менее 1 мкм) размерам (электронолито-графия, рентгенолитография). Существенное уменьщение глубин залегания р-п переходов связано прежде всего с освоением технологии ионного легирования, которое, однако, обладает существенным недостатком: очень высок уровень дефектности областей кремния, непосредственно подверг-щихся ионной бомбардировке. Эти недостатки могут быть устранены следующим образом: на подложку с эпитаксиальным слоем наносится пленка поликристаллического кремния, которая и подвергается локальной ионной бомбардировке. Затем проводится диффузионный отжиг, в процессе которого легирующая примесь диффундирует из поликремния в монокристаллическую подложку на небольшую глубину. Конструкция сформированного таким образом быстродействующего транзистора показана на рис. 2.21. Она сформирована в эпитаксиальном слое /г-типа толщиной 1,5 мкм, глубина эмиттерного Рис. 2.21. Структура быстродействующего биполярного транзистора: /-подложка; 2- скрытый слой 3- изолирующая область; 4- эпитаксиальиый слой; 5-терми ческий окисел, б- область пас сивной базы; 7- область актив-ной базы; 8~ эмиттерная об ласть; 9- пленка поликристал лического кремния; 10- алюми ииевая разводка 3 8 7
перехода составляет 0,2 мкм. Транзистор имеет следующие параметры: ;кБо=8...12 В; (;эБо=3,5...6,0; и^э=Б...\2 В; S = 40...70. Транзисторы микросхем с эмиттерами на гетеропереходах. Гетеропереходы - это переходы между двумя материалами, имеющими различную ширину запрещенной зоны. В обычных транзисторах используются гомопереходы, так как ширина запрещенной зоны кремния по обе стороны перехода одинакова и равна 1,1 эВ. Теоретически преимущества гетеропереходов известны давно, но технология их формирования не была разработана. ранзисторы с гетеропереходами изготавливаются (рис. 2.22) с использованием легированного фосфором низкоомного полуизолирующего поликристаллического кремния в качестве материала эмиттера, который предложившая эту технологию японская фирма Sony назвала Sipos (semi-insulting poiycrystaiiine silicon - полуизолирующий поликристаллический кремний). Этот материал представляет собой смесь поликристаллического кремния и двуокиси кремния и имеет ширину запрещенной зоны 1,3...1,4 эВ. Разница в ширине запрещенной зоны в 0,2...0,3 эВ материалов, образующих эмиттерный переход, обеспечивает значительно более высокий коэффициент инжекции. Это означает, что в полном токе через эмиттерный переход отношение тока электронов к току дырок получается намного выше. От коэффициента инжекции непосредственно зависит коэффициент усиления транзистора (см. § 2.2). В обычном кремниевом транзисторе (рис. 2.22, б) единственный способ повышения этого параметра состоит в увеличении концентрации примеси в эмиттере и уменьшении концентрации примеси в базовой области. В транзисторах с эмиттерами на гетеропереходах высокий коэффициент инжекции можно обеспечить и при относительно сильно легировйнной базовой области. Меньшее сопротивление пассивной  Рис. 2.22. Вертикальная структура интегрального транзистора с эмиттером на гетеропереходе (а) и ее сравнение со структурой интегрального планарно-эпитаксиального транзистора (б) области базы дает возможность значительно повысить быстродействие транзисторов без уменьшения или даже с увеличением коэффициента усиления по току. В гетеропереходе (рис. 2.22, а) пленка полуизолирующего поликристаллического кремния толщиной около 0,2 мкм контактирует непосредственно с базовой областью транзистора. Поверх нее наносится обычная пленка легированного поликристаллического кремния толщиной 0,3...0,5 мкм, с которой контактирует металлическая разводка. Технологическая реализация транзисторов микросхем с гетеропереходами не связана со сложными усовершенствованиями отдельных операций или уменьшением геометрических размеров транзис-iopoB. По этой технологии возможно получение микросхем с рабочим быстродействием в 1...5 ГГц. 2.5. ИНТЕГРАЛЬНЫЕ РЕЗИСТОРЫ Резисторы микросхем изготавливаются на основе диффузионных слоев транзисторной структуры (эмиттерная и базовая области), в эпитаксиальном слое (коллекторная область) и с помощью ионного легирования. Диффузионные резисторы изготавливают одновременно с базовой или эмиттерной областью транзистора. Структура таких резисторов показана на рис. 2.23. Сопротивление тела диффузионного резистора (ДР) представляет собой объемное сопротивление участка диффузионного слоя, ограниченного р-п переходом. Оно определяется геометрическими размерами резистивной области и характером распределения примеси по глубине диффузионного слоя, которое, в свою очередь, характеризуется удельным поверхностным сопротивлением ps. При создании микросхем параметры диффузионных слоев оптимизируются с целью получения наилучших характеристик п-р-п-транзисторов, поэтому параметры ДР улучшаются не за счет варьирования технологических режимов, а вы.бором конфигу-  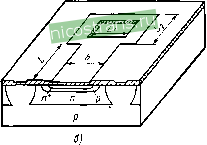 Рис. 2.23. Структура диффузионных резисторов на основе базовой (а) и эмиттерной (б) областей, сформированных по планарно-эпитаксиальной технологии и □ □
□
□ □ Рис. 2.24. Варианты конфигураций диффузионных резисторов рации и геометрических размеров тела резистора (рис. 2.24). Низко-Омные резисторы (десятки ом) имеют форму, представленную на рис. 2.24, а и малое отношение 1/Ь. Форма и размеры контактов к ним выбираются такими, чтобы сопротивление приконтактных областей было значительно меньше сопротивления основной области резистора. Резисторы с сопротивлением в сотни ом и до единиц килоом в плане имеют вид, изображенный на рис. 2.24, в, б, в котором длина и ширина приконтактной области равна ширине резистора. Топология, показанная на рис. 2.24, д, г, используется для создания высокоомных резисторов. В ней тело резистора имеет сравнительно малую ширину, контактные области имеют размеры, определяемые возможностями технологии по созданию надежного контакта проводящих А1 полосок с полупроводниковым материалом. Еще более высокоомные резисторы имеют форму меандра (рис. 2.24, е) или изготавливаются в донной части базового слоя (пинч-резисторы, рис. 2.24, ж). Длина однополоскового диффузионного резистора не может превышать размеров кристалла (т. е. 1...5 мм), ширина ограничена минимальной шириной окна под диффузию, определяемой возможностями фотолитографии (2,5...3 мкм), и боковой диффузией (уход под окисел равен примерно глубине залегания диффузионного р-п перехода). Типичные значения сопротивления ДР, которые можно получить при данной величине ps, лежат в диапазоне 0,25 ps<?<10 Ps. Нижний предел ограничивается сопротивлениями контактных областей, верхний - допустимой площадью, отводимой под резистор. л  1 P-Si Рис. 2.25. Конструкция пинч-резис тора Воспроизводимость номинальных значений сопротивления ДР обычно составляет 15...20% и зависит от ширины резистора. Отклонения от номиналов сопротивлений резисторов, расположенных на одном кристалле, за счет неточностей технологии имеют один и тот же знак, т. е. меняются в одну сторону, поэтому отношение сопротивлений сохраняется с высокой точностью. Аналогично температурный коэффициент отношения сопротивлений мал по сравнению с ТКС для отдельного резистора (0,15...0,3%/°С). Эта особенность ДР учитывается при разработке полупроводниковых микросхем. На основе эмиттерной области формируются резисторы небольших номиналов (3...100 Ом с ТКС 0,01...0,02%/°С), поскольку эмиттерного слоя невелико (табл. 2.1). Пинч-резисторы. При необходимости создания в микросхемах резисторов с большим сопротивлением используют пинч-резисторы (синонимы: канальные, сжатые, закрытые резисторы). Они формируются на основе донной слаболегированной области базового слоя с большим сопротивлением и имеют меньшую площадь сечения (рис. 2.25). Максимальное сопротивление таких резисторов составляет 200...300 кОм при простейшей полосковой конфигурации, Ps=2...b кОм/П. Пинч-резисторы имеют большой разброс номиналов (до 50%) из-за трудностей получения точных значений толщины донной части р-слоя, большой ТКС (0,3...0,5%/°С) из-за меньшей степени легирования донной части. У пинч-резистора и р-слои закорочены металлизацией (рис. 2.25) и соединены с выводом резистора, находящимся под большим положительным потенциалом, чем остальные области структуры. Такое соединение обеспечивает обратное смещение на всех переходах пинч-резистора. Этот резистор имеет линейный участок ВАХ только до напряжений 1...1,5 В, его пробивное напряжение 5...7 В (эмиттерный переход, см. табл. 2.2). Их структура такая же, как и у ДР, но глубина ионно-легированных слоев, в которых сформировано тело резистора, составляет лишь Рис. 2.26, Конструкция ионно- легированных резисторов, сформированных имплантацией примеси р-типа в эпитаксиальиый (коллекторный) слой (а) и примеси п-типа в базовый слой (б)    0,1. .0,3 мкм (рис. 2.26). Ионная имплантация может обеспечить малую концентрацию легирующей примеси в слое. При соответствую-ш,ем выборе дозы легирования и параметров отжига (10...20 мин при 500...600 °С) можно получить ps=0,5...20 кОм/П в резисторах, изображенных на рис. 2.26, а, и ps=500...1000 Ом/П в резисторах, изображенных на рис. 2.26, б. Могут быть достигнуты номиналы сопротивлений в сотни килоом со сравнительно низким ТКС и с допуском +10%. Ширина и толщина ионно-легированных резисторов с большими номиналами сопротивлений очень малы, что усложняет получение хорошего омического контакта к ним. В качестве контактов к ним используют диффузионные области р- или п-типа, которые формируют на стадии базовой или эмиттерной диффузии. Частотные характеристики интегральных резисторов. Любой интегральный резистор обладает паразитной емкостью С относительно подложки или изолирующего кармана. Постоянная времени, определяющая длительность переходного процесса x=RC, и соответствующая граничная частота р=1/(2лт)==1/(2л^?С). Для интегральных ДР /тp l/(Зp.Co/), (2.9) (2.10) где Со - емкость на единицу площади р-п перехода. Характерно, что frp уменьшается пропорционально квадрату длины резистора. Для типичного ДР на базовом слое (ps=200 Ом/П, /=1 мм, 6=10 мкм) frp~10...15 мГц. Это означает, что резистор имеет чисто активное сопротивление только до указанных частот, при более высоких частотах его сопротивление становится комплексным. При использовании диэлектрической изоляции вместо изоляции р-п переходом frp для одной и той же конструкции резистора может быть выше в несколько раз. Тонкопленочные резисторы. В совмещенных микросхемах поверх слоя защитного диэлектрика могут быть сформированы тонкопленочные резисторы. По сравнению с полупроводниковыми они имеют следующие преимущества: более высокие значения frp, меньшие значения паразитных параметров, более высокая точность изготовления, низкий ТКС. 2.6. ИНТЕГРАЛЬНЫЕ КОНДЕНСАТОРЫ В интегральных полупроводниковых конденсаторах роль диэлектрика могут выполнять обедненные слои обратносмещенных р-п переходов или пленка окисла кремния, роль обкладок - легированные полупроводниковые области или напыленные металлические пленки. Характеристики конденсаторов полупроводниковых микросхем невысоки, а для получения больших емкостей необходимо использовать -C3* Рис. 2.27. Варианты формирования интегральных диффузионных конденсаторов на основе р-п переходов значительную площадь схемы. Поэтому при проектировании электрической схемы полупроводниковой микросхемы стремятся конденсаторы исключить. Диффузионные конденсаторы (ДК). Для их формирования может быть использован любой из р-п переходов (рис. 2.27): коллектор-подложка (Ci), база - коллектор (С2), эмиттер - база (Сз), переход р-области изолирующей диффузии и п+-область скрытого слоя (С4). Варианты Ci и С4 не могут быть реализованы в микросхемах с диэлектрической изоляцией. Поскольку ширина обедненного слоя обратносмещенного перехода зависит от напряжения, емкость ДК тоже меняется с изменением напряжения. Удельную емкость любого полупроводникового перехода можно аппроксимировать формулой со /(-(1/t/) , где К - коэффициент пропорциональности, зависящий от уровня легирования диффузионных областей, показатель -i-], причем ш=/2 соответствует ступенчатому, а т=/з - линейному переходам. Остальные значения т, входящие в указанное множество, соответствуют реальным профилям распределения. Эмиттерный переход обладает наибольшей удельной емкостью, но малыми пробивным напряжением и добротностью. Коллекторный переход используется наиболее часто для формирования ДК (рис. 2.28).. г 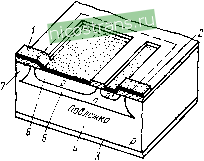 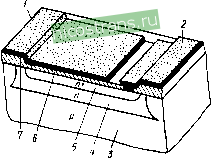 Рис. 2.28, Конструкция интегрального диффузионного кон.аенсатора; /-алюминиевый вывод от верхней обкладки конденсатора; 2-- алюминиевый вывод от нижней обкладки конденсатора; 3- контакт к подложке; 4- подложка р-типа; 5- коллекторная п-область (нижняя обкладка конденсатора); 6-базовая р-область (верхняя обкладка конденсатора); 7- пленка окисла кремния Рис. 2.29. Конструкция интегрального МДП-конденсатора: 1- верхняя обкладка; 2- алюминиевый вывод ir нижней обкладки; 3-подложка р-типа; 4- кот лекторная п-область; 5-л'слой (нижняя обкладка конденсатора); 6- тонкий окисел (диэлектрик конденсатора); 7-толстый окисел К недостаткам ДК можно отнести необходимость обеспечения их строго определенной полярности (рис. 2.27), так как условием нормальной работы ДК является обратное смещение р-п перехода. МДП-конденсаторы. Их конструкция представлена на рис. 2.29. Нижней обкладкой служит эмиттерный -слой, верхней - пленка А1. Диэлектриком служат тонкие слои ЗЮг или Si3N4, последний предпочтителен в связи с большей Со (е нитрида выше, чем окисла кремния), но ЗЮг более доступен. Толщина диэлектрика составляет 0,05...0,12 мкм. Недостатком МДП-конденсаторов в составе биполярных микросхем является необходимость введения дополнительной операции создания тонкого диэлектрика (и, естественно, дополнительной операции фотолитографии). Тонкопленочные МДМ-конденсаторы в совмещенных микросхемах состоят из двух металлических слоев, разделенных слоем диэлектрика. В качестве обкладок обычно используется А1, или Та, тогда в первом случае диэлектриком служит АЬОз, во втором - ТагОа. Диэлектрическая постоянная ТагОа на порядок выше, чем у большинства других диэлектриков, но он не используется в микросхемах, работающих на высоких частотах. МДМ-конденсаторы, как и МДП-конденсаторы, работают при любой полярности. Их недостатком является удлиненный технологический маршрут изготовления и необратимый отказ в случае пробоя диэлектрика. 2.7 ФУНКЦИОНАЛЬНО-ИНТЕГРИРОВАННЫЕ ЭЛЕМЕНТЫ БИС Повышению быстродействия БИС наряду с созданием специально разработанных активных элементов (§ 2.4) способствовало применение функционально-интегрированных элементов. Дело в том, что при классической интеграции элементов в одном кристалле повышению степени интеграции и увеличению быстродействия препятствуют большое число выполненных отдельно и изолированных активных и пассивных элементов, к каждому из которых должны быть сформированы контактные окна. При таком обилии контактных окон возникают сложные проблемы создания межэлементной коммутации. В современных БИС и СБИС реализованы элементы, в которых одна и та же область полупроводниковой сруктуры одновременно выполняет несколько функций. Например, области базы или коллектора транзистора могут одновременно использоваться в качестве резисторов. Более глубокая интеграция осуществлена в конструкции триггера, показанной на рис. 2.30. В ней нагрузочные резисторы R}, R2 совмещены с коллекторами транзисторов УГ/, VT2 соответственно. Для увеличения сопротивления резисторов R1 и R2 одновременно с формированием базовых областей транзисторов проведена диффузия примеси /з-типа электропроводности, за счет чего уменьшено поперечное сечение резисторов (см. § 2.5). Формирование еще 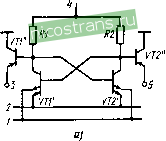 Lttil Рис. 2.30. Схема (а) и конструкция (б) триггера, в которой совмещены коллекторы ключевых транзисторов с нагрузочными резисторами и базами транзисторов связи кг/ VT1 лишь двух р-областей с контактами позволяет использовать вертикальные р-п-р-структуры в качестве транзисторов связи VTl и VT2 . Таким образом, здесь совмещены функции п-области. Она выполняет роль коллектора транзисторов УТГ и VT2, базы транзисторов VTl и VT2 , сжатых резисторов R1, R2. В БИС по-иному на основе функционально-интегрированных элементов организованы цепи электропитания: традиционные резис-тивные цепи питания заменены либо диодными, либо транзисторными, либо инжекционными. Функции нагрузочных резисторов в цепи питания в функционально-интегрированном логическом элементе с транзисторной цепью питания (рис. 2.31) выполняют р-п-р-транзисторы. На рис. 2.31 функционально-интегрированные элементы выделены штриховой линией. Конструктивно-топологическое решение <1  Рис. 2.31. Функциональио-иитегрированный элемент с транзисторной цепью электропитания; а - электрическая схема; 6-топология; в - поперечный разрез 58 цепи электропитания элемента, изображенного на рис. 2.31, реализовано таким образом, что базовая область р-п-р-транзистора одновременно является эмиттером переключающего п-р-п-тран-зистора, а база п-р-п-транзистора одновременно выполняет функции коллектора р-п-р-транзистора. Функционально-интегрированный элемент, представленный на рис. 2.31, на поверхности кристалла имеет только функциональные межэлементные соединения. Шины элекропитания в нем образованы подложкой и эпитаксиальным слоем. Это очень перспективное решение для создания матричных БИС. В БИС могут быть функционально совмещены рабочие области различных активных элементов. Примеры такого совмещения нами уже рассмотрены: это составной транзистор, расположенный в одной изолированной области (см. рис. 2.15), это транзисторы с диодом Шотки (см. рис. 2.19, 2.20), это, наконец, структура элемента И^Л (см. рис. 1.19), в которой одна область служит базой транзистора п-р-п-типа и одновременно коллектором горизонтального транзистора р-п-р-типа, а другая - область эмиттера транзистора п-р-п-типа - служит базой транзистора р-п-р-типа. Использование функционально-интегрированных элементов в БИС приводит к существенному повышению быстродействия с одновременным повышением степени интеграции, упрощению коммутационных систем, сокращению длины соединительных проводников и числа контактных окон. Функционально-интегрированные элементы особенно часто используют при создании матричных БИС, микросхем микропроцессорных наборов, СБИС запоминающих устройств и однокристальных ЭВМ. 2.8. КОНСТРУКТИВНО-ТЕХНОЛОГИЧЕСКИЕ ВАРИАНТЫ ИЗОЛЯЦИИ ЭЛЕМЕНТОВ МИКРОСХЕМ ДРУГ ОТ ДРУГА При отсутствии изоляции элементов биполярных микросхем все они окажутся электрически связанными между собой через подложку. Изоляцию осуществляют с использованием нескольких конструктивно-технологических вариантов. Изоляция обратно-смещенными р-п переходами (см. рис. 1.10, 1.11). Этот способ, будучи исторически первым, распространен и по сей день, так как обладает высокой технологичностью, операции создания изолирующей области (дополнительно одна операция фотолитографии и одна операция диффузии) естественным образом вливаются в технологический маршрут, не требуют ни дополнительного оборудования, ни использования новых материалов. Конструкция транзистора, изолированного от других элементов микросхемы р-п переходом, показана на рис. 2.32, а. Недостатком этой конструкции является то, что площадь изолирующей области сравнима с площадью, отводимой под транзистор, и даже превышает ее (см.   Рис. 2.32. Конструкции интегральных биполярных транзисторов с изоляцией обратно-смещеииыми р-п переходами, изготовленных по планарно-эпитаксиальной технологии (а) и по технологии коллекторной изолирующей диффузии (б) рис. 1.10). Попытка устранить хотя бы частично этот недостаток без изменения способа изоляции привела к созданию транзистора, изображенного на рис. 2.32, б, в котором изолирующая область сформирована диффузией примеси п-типа на всю глубину эпитаксиального слоя до соприкосновения со скрытым п+-слоем и используется в качестве коллекторной области транзистора. Изоляция элементов полупроводниковых микросхем с помощью обратносмещенного р-п перехода кроме указанного имеет и другие принципиально неустранимые недостатки. К ним относятся; большая паразитная емкость изолирующих р-п переходов и появление дополнительных паразитных элементов в структуре микросхемы; необходимость подачи на изолирующий р-п переход определенного по величине и знаку напряжения смещения; наличие четырехслойных структур п-р-п-р и р-п-р-п-типа, которые обладают положительной обратной связью по току, вследствие чего при воздействии на них ионизирующих факторов увеличение тока через эти структуры будет приво-<дить к еще большему его возрастанию. Указанные недостатки не позволяют добиться существенных успехов в росте быстродействия микросхем, увеличения степени их интеграции, радиационной стойкости и стабильности в интервале температур. Изоляция диэлектриком. Конструкция интегрального транзистора, изолированного от соседних элементов микросхемы с помощью диэлектрика, показана на рис. 2.33. Пленка диэлектрика (ЗЮг) и непроводящая подложка устраняют кардинальным образом недостатки, присущие изоляции р-п переходами. Но для осуществления такого способа изоляции необходим довольно сложный технологический процесс (см. гл. 7), включающий в себя операции по размещению в диэлектрическом материале островков монокристаллического кремния и операции по формированию р-п переходов в этих островках (рис. 2.33, а). Труден подбор материала диэлектрической подложки для этой конструкции, поскольку коэффициенты термического расширения подложки и монокристаллического кремния должны совпадать, иначе проведение операций, связанных с нагревом, станет невозможным из-за коробления структур и появления дефектов в кристаллической решетке кремния.  3 6 н Рис. 2.33 Конструкции интегральных транзисторов с изоляцией диэлектриком: а -структура Kpeitfaaii в диэлектрике (КВД); 6 - структура кре| иий на диэлектрике (КНД) со сфорыи-рбваииым торцевым тразистором с вертикальными р-п переходами Структура, изображенная на рис. 2.33, а, носит название кремний в диэлектрике (КВД), а структура на рис. 2.33, б--кремний на диэлектрике (КНД). Технология изготовления таких структур описывается в § 6.4. Основными недостатками конструкций с диэлектрической изоляцией элементов являются: сложный технологический процесс и малый выход годных микросхем; плохой отвод тепла от элементов микросхемы в подложку, поскольку тепловое сопротивление диэлектрических материалов в десятки раз больше теплового сопротивления монокристаллического кремния; трудность создания разводки из-за сравнительно большого перепада высот рельефа поверхности в структурах КНД; высокая плотность дефектов структуры в изолированных островках кремния и низкая воспроизводимость параметров элементов микросхем. Комбинированная изоляция сочетает технологичность изоляции р-п переходом и высокие качества диэлектрической изоляции: элементы микросхемы со стороны подложки изолированы обратно-сме-щенными р-п переходами, а с боковых сторон - диэлектриком (окислом, стеклом, керамикой, поликремнием и т. д.). Таким образом, изоляция р-п переходами заменяется изоляцией диэлектриком в наиболее уязвимом приповерхностном слое и с боковых сторон. Наибольшее распространение сегодня получили такие варианты комбинированной изоляции, как локальное окисление (изопланарная технология) (рис. 2.34, а) и вертикальное анизотропное травление с последующим заполнением канавок поликристаллическим кремнием (полипланарная технология) (рис. 2.34, б). Э д  Рис. 2.34. Конструкции интегральных транзисторов с комбинированной изоляцией, полученных локальным окислением кремния (а) и анизотропным травлением кремния с последующим окислением профилированной поверхности и заполнением окисленных канавок поликристаллическим кремнием (б) 1 2 3 4 5 6 ... 20 |
|||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||