
 | |
 |
Главная » Мануалы 1 ... 4 5 6 7 8 9 10 ... 20
2 / I- Исток 3.35. Эквивалентная схема запоминающего элемента с двумя затворами на основе п-канального МДП-транзистора: управляющий затвор; 2- плавающий затвор Подложка состояния транзистора определяются зарядом на плавающем затворе. Зарядка плавающего затвора, как и для других описанных выше ячеек, осуществляется горячими электронами, проходящими через слой подзатворного диэлектрика толщиной 0,05...0,1 мкм, однако механизм разогрева электронов в данном приборе иной. В режиме зарядки плавающего затвора на сток и затвор одновременно подается большое положительное напряжение (около 20 В). При этом наличия электрического поля вблизи стокового перехода еще не достаточно, чтобы вызвать его пробой на подложку, но достаточно, чтобы вызвать ударную ионизацию в канале транзистора. Число горячих электронов будет определяться током в канале МДП-транзистора. Инжекция горячих электронов в плавающий затвор осуществляется под действием тянущего поля со стороны управляющего затвора. Очень важно то, что величина накопленного заряда определяется геометрическими параметрами ячейки памяти и амплитудой импульсов записи, прикладываемых к управляющему затвору стоку ячейки. На рис. 3.35 представлена эквивалентная схема запоминающих элементов, структура которых дана на рис. 3.34. Потенциал на плавающем затворе определяется по формуле Смз+Сзп+С (3.14) потенциал на управляющем где Смз - межзатворная емкость, Uуз -затворе; t/c- потенциал на стоке. Транзистор буЛет открыт, когда напряжение на плавающем затворе достигнет величины Uo. При этом на управляющий затвор необходимо подать напряжение: пз(Смз+зп) Q С1 С.. (3.15) В незаряженном состоянии пороговое напряжение ячейки имеет низкое значение (t/o2...3 В), а после зарядки плавающего затвора электронами оно возрастает на величину Q/C 3. Согласно зависимости (3.14), (3.15) (рис. 3.36) для получения большего сдвига Uo (т. е. для более эффективной зарядки плаваю- Щ.В  15 20 25 30 35 40 Щз,8  hnj0,0BHKH Ь„п=0,12мкм Uc- 11В ичу-25В BOO S,mm Рис. 3.36. Характер зависимости изменения порогового напряжения запоминающего МДП-транзистора от напряжения на управляющем затворе (а), нло1цади перекрытия управляющего и плавающего затворен (6) и от толщины межзатворного диэлектрика (в) 0,0В 0,07 0,08 0,09 0,1 h,MKM щего затвора) необходимо увеличить емкостную связь управляю-ш.его затвора с плавающим или потенциал на плавающем затворе. Также важно правильно выбрать длину канала МДП-транзистора. Это необходимо для нормального процесса зарядки плавающего затвора. Длина канала по расчетам и экспериментальным данным не должна превышать 3...4 мкм, чтобы разогрев электронов в канале был возможен при меньших напряжениях на стоке. На рис. 3.37 приведены входные характеристики л-канального МДП-транзистора с двумя затворами до и после зарядки плавающего затвора, из которых видно, что пороговые напряжения МДП-ятранзистора с заряженным и незаряженным плаваюи^им затвором существенно различаются и, если на управляющий затвор подать напряжение считывания Uo\<.Uc<Uo2, то транзистор с незаряженным плавающим затвором будет открыт (график /), а с заряженным- закрыт (график 2). Из этого следует важный вывод о возможности построения на п-канальных МДП-транзисторах с двумя затворами матричного накопителя ЭСППЗУ с одним запоминающим элементом; фрагмент такого накопителя показан на рис. 3.38. В последних разработках электрически перепрограммируемых ячеек памяти стремятся к понижению напряжений, управляющих режимами записи - стирания. Это становится возможным прежде всего за счет создания воспроизводимой и высококачественной технологии получения тонких диэлектрических слоев, изолирующих плавающий затвор. Подход к этой проблеме учитывает противоре- Рис. 3.37. Входные характеристики запоминающего элемента ЭСППЗУ на п-канальных МДП-транзисторах с поликремниевыми управляющими и плавающими затворами: ло зарядки плавающего затвора; 2- после заряд-и плавающего затвора  
I I I i I I I I Рис. 3.38. Фрагмент матричного накопителя на /1-канальном МДП-транзисторе с поликремниевыми плавающим и управляющим затворами (а) и фрагмент его топологии (б) чивость требований, возникающих в процессе записи - хранения - стирания в таких энергонезависимых полупроводниковых ЭСППЗУ, хранящих информацию в виде электрического заряда. Противоречивость эта заключена в том, что нужно найти способ быстрой записи информации с малым потреблением энергии, который сочетался бы в одной конструкции со способом бесконечно длительного хранения этой информации. При реализуемых в настоящее время размерах запоминающих элементов на плавающем затворе хранится заряд всего в несколько миллионов электронов. Для передачи на плавающий затвор такого количества электронов за цикл программирования, равный 10 мс, средний ток программирования элемента должен составлять 10 ° А. С другой стороны, необходимо, чтобы за 10 лет хранения информации утечка хранимого заряда составила менее 10%, т. е. ток утечки не должен превышать 10~ А. Реализовать отношение этих токов, равное 1:10 ,- проблема технически исключительно сложная. Известно мало механизмов инжекции заряда, которые после программирования, да еще при малых напряжениях записи, выключались бы абсолютно надежно и обеспечивали получение указанного выше отношения токов. Решение проблемы, как оказалось, нашлось на том пути, который сначала представлялся невозможным. После исследования многих методов генерирования электронов с высокой энергией (горячих) было решено подойти к проблеме с другой стороны: найти способ проникновения электронов с низкой энергией через окисел. Реализовать такой способ можно было с помощью туннелирования Фаулера-Нордхейма, представляющего собой хорошо известный физический механизм, который проиллюстрирован с помощью зонной диаграммы на рис. 3.39. По существу, дело здесь заключается в том, что когда электрическое поле в диэлектрике становится больше примерно 10 В/см, электроны с отрицательно заряженного электрода (на рис. 3.39, а- это поликремний) могут попасть в зону проводимости диэлектрика. Пройдя лишь очень короткое расстояние через его запрещенную зону, эти электроны свободно достигают положительного электрода. Однако на пути к использованию этого механизма возникли две большие трудности. Во-первых, всегда считалось, что при электрических полях около 10 В/см в двуокиси кремния происходит катастрофический пробой, и поэтому в нормальных режимах работы поля в МДП-транзисторах были на порядок ниже. Во-вторых, для возникновения туннелирования по указанному механизму при приемлемых с практической точки зрения напряжениях (20 В) толщина окисла должна быть меньше 20 нм. Окисные пленки толщиной менее 50 нм редко изготавливались даже при экспериментальных исследованиях, поэтому были опасения, что плотность дефектов в таких тонких пленках может оказаться недопустимо высокой. Однако этим недостаткам противостоят следующие достоинства. Процесс туннелирования в общем случае идет с малым расходом энергии и с высокой эффективностью, что обусловливает малое потребление мощности. Туннелирование электронов через диэлектрик по данному механизму - процесс двусторонний, и его можно использовать как для заряда, так и для разряда затвора. И наконец, область туннельного окисла может быть сделана очень малой по площади, что, естественно, хорошо согласуется с требованием получения высокой плотности упаковки. Вследствие этих побудительных причин были начаты работы по Созданию методов выращивания надежных окисных и нитридных пленок толщиной менее 20 нм с малой плотностью дефектов. К настоящему времени рекордным в этом отношении прибором является МДП-транзистор с окисно-нитридным диэлектриком толщиной н еВый затвор онисел 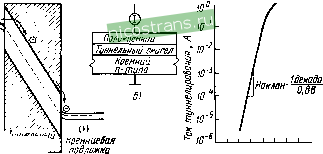 6 8 10 12 те 18 20 Напряжение, В S) Рис. 3.39. Механизм туннелирования электронов через тонкий окисел (а), структура запоминающего элемента с туннельным окислом (б), вольт-ампериая характеристика эффекта туннелирования по механизму Фаулера-Нордхейма (в) 10 нм (0,01 мкм). Подзатворный диэлектрик такой толщины полу-чается при термическом окислении пленки нитрида кремния, выращенной перед этим путем термической нитридизации поверхности кремния при температурах свыше 1100°С в среде аммиака. Чистый подзатворный нитридный диэлектрик трудно вырастить термическим способом с необходимой заранее толщиной, целостностью и требуемой электрической прочностью, а слои окисла толщиной менее 20 нм обычно имеют слишком много дефектов. Разработанные окисно-нитридные диэлектрики имеют толщину 10... 15 нм, обладают приемлемой воспроизводимостью и вместе с тем имеют вполне приемлемые пробивные напряжения. После окисления пленки нитрида кремния чистый нитрид остается только на границе с подложкой, а далее диэлектрик плавно переходит в двуокись кремния. Используя такой подзатворный диэлектрик, можно получить МДП-прибор с дифференцированным потенциальным барьером: высота этого барьера со стороны подложки при программировании ЭСППЗУ получается намного меньше высоты барьера, действующего в противоположном направлении. В результате может быть получен запоминающий элемент с напряжением программирования менее 12 В, имеющий хорошие характеристики хранения информации. Успехи технологии формирования тонких бездефектных диэлектрических слоев на кремнии позволили разработать конструкции электрически перепрограммируемых ячеек памяти, работающих на эффекте туннелирования (рис. 3.40). На плавающем и управляющем кремниевых затворах в этих конструкциях имеются ступеньки в областях перехода к более тонкому туннельному диэлектрику. В варианте конструкции, изображенном на рис. 3.40, а, туннельный окисел располагается над областью канала. При подаче на верхний затвор напряжения соответствующей полярности при нулевом напряжении на остальных электродах, на плавающий затвор УЗ ПЗ 4 5  Рис. 3.40. Варианты запоминающих элементов ЭСППЗУ на п-канальных МДП-транзисторах с двумя поликремниевыми затворами и тонким по.чзатворным туннельным диэлектриком: /- толстый окисел; 2- металлическая шииа, 3- межзатворный диэлектрик; 4- тонкий туннельный диэлектрик через емкостную связь передается положительное напряжение. Электроны при этом проходят через туннельный окисел и заряжают плавающий затвор. И наоборот, при подаче к областям стока, истока и подложки положительного потенциала ( + 17 В) при нулевом потенциале на управляющем затворе происходит разрядка плавающего затвора. Для создания на основе запоминающего элемента, изображенного на рис. 3.40, а, схемы ЭСППЗУ необходимо осуществить развязку между матричным накопителем и схе-мой^управления. С этой целью запоминающий элемент размещают в р~-кармане, сформированном в подложке и-типа. Во втором варианте (рис. 3.40, б) туннельный окисел расположен над стоковой п+-областью. Сформировать тонкий окисел над п+-областью сложнее, однако преодоление этих технологических трудностей позволяет создать схему ЭСППЗУ, в которой кроме избирательной (побайтовой) записи можно осуществить и избирательное стирание. Под действием разности потенциалов между плавающим затвором и стоком в туннельном окисле можно создавать электрическое поле разной направленности - вытягивающее электроны с области стока на плавающий затвор и снимающего заряд с плаваю-ш,его затвора. Таким образом, структуры с туннельным окислом позволяют просто и воспроизводимо выполнять как программирование, так и стирание запоминающего элемента. Но возникает вопрос о том, насколько надежно будет сохраняться записанный заряд и не понадобится ли регенерация информации при таком тонком окисле. Ответом на этот вопрос является график, показанный на jpnc. 3.39, в, который свидетельствует об очень сильной зависимости туннельного тока от напряжения на окисле. Как видно из графика, туннельный ток возрастает на порядок при увеличении приложенного напряжения на каждые,0,8 В. Если выполнить сформулированное выше требование о различии токов программирования и утечки на 11 порядков, то становится ясным, что разница между напряжением на туннельном окисле во время программирования и во время считывания должна превышать 8,8 В. Такая величина, дополненная соответствующими запасами на технологические разбросы, является вполне приемлемой. Кроме того, надо учесть, что в процессе считывания и хранения никакого разрушения информации не происходит, и поэтому при нормальных условиях работы ЗУ или пассивного хранения в нем информации никакая ее регенерация не нужна. Экспериментальные исследования подтвердили, что структура, изображенная на рис. 3.40, б, может сохранять информацию в течение более 10 лет при температуре 125°С. Другим важным моментом является поведение электрически Стираемого запоминающего элемента при многократных повторениях циклов запись - стирание. Эта характеристика обычно называется долговечностью элемента памяти и связана с деградацией свойств диэлектрика, вызванной захватом электронов на его ловушках и  Рис. 3.41. Изменение пороговы.х напряженим Ui)i и (Уо2 запоминающего элемента ЭСППЗУ с увеличением числа циклов программирова ние - стирание информации при незаряжен ном (кривая /) и заряженном (кривая 2) сое тоянии плавающего затвора образованием в нем объемного заряда. Как показано на рис. 3.41, по мере возрастания количества циклов запись - стирание пороговые напряжения запоминающего элемента и в заряженном и в незаряженном состояниях изменяются таким образом, что их разность уменьшается и становится меньше 8,8 В, что означает, по существу отказ элемента памяти. К счастью, это происходит только после очень большого количества циклов (10*...10 ), что практически обеспечивает необходимый срок службы запоминающего элемента В ячейке ЭСППЗУ, структура и топология которой приведены на рис. 3.42, использован ряд новых конструктивных усовершенствований. В ней применяется п-канальный МДП-транзистор с коротким (3,5 мкм) каналом и с поликремниевым управляющим затвором, расположенным над плавающим затвором. Последний перекрывает лишь часть канала, прилежащую к стоковой области, и в стороне от канала лежит над небольшим участком области истока. Управляющий затвор перекрывает плавающий затвор и область канала. Толщина межзатворного и подзатворного диэлектриков (окись кремния) имеет обычные для МДП-технологии значения 0,07...0,12   Рис. 3.42. Структура и топология запоминающего элемента ЭСППЗУ на я-канальио МДП-транзисторе с двумя поликремииевыми затворами - управляющим (УЗ)* плавающим (ПЗ): 1~ межзатворный диэлектрик; 2- подзатворный диэлектрик; 3- туннельный диэлектрик; 4~ толстый i сел; ,5- область перекрытия плавающим затвороч истоковой области для стирания информации мкм, а толщина туннельного окисла в области стирания значительно меньше (0,03...0,05 мкм). Подобная конструкция довольно часто используется для построения ЭСППЗУ. Она не требует введения в схему ячейки памяти дополнительных транзисторов выборки, что существенно уменьшает площадь. Для программирования применяется инжекция электронов из л-канала в плавающий затвор. Для усиления инжекции канал сделан воронкообразным с уменьшающимся к области стока сечением. Программирование осуществляется одновременным подключением достаточных напряжений к стоку и управляющему затвору при заземленном истоке. В канале возникают горячие электроны, которые инжектируются в плавающий затвор (ПЗ) и изменяют пороговое напряжение МДП-транзистора. Пороговое напряжение неза-программированной ячейки равно приблизительно 1 В. В процессе программирования оно повышается до 8 В. При этом хранение О соответствует состоянию транзистора с незаряженным плавающим затвором. Считывание осуществляется дискриминацией двух состояний (Uo=\ В и Uo=8 В) с помощью считывающего импульса со стандартным напряжением 5 В, прикладываемого к управляющему затвору. Электрическое стирание информации, т. е. разрядка плавающего затвора, производится над областью истока, расположенной над плавающим затвором. Для этого импульс стирания амплитудой примерно -f 35 В прикладывается к истоку И, при этом управляющий затвор УЗ заземляется, а сток С остается свободным. За счет емкостной связи в туннельном диэлектрике создается сильное электрическое поле, под действием которого осуществляется туннелирование электронов с плавающего затвора в исток по механизму Фаулера-Нордгейма. На основе рассмотренных п-канальных МДП-транзисторов с двумя уровнями поликремния с тремя слоями тонкого окисла (подзатворный, межзатворный и туннельный) может быть спроектировано программируемое логическое устройство (ПЛУ) с электрически изменяемой конфигурацией, очень удобное для быстрого изготовления заказных логических микросхем. 3.7. КОНСТРУКЦИИ И МАТЕРИАЛЫ ЭЛЕМЕНТОВ КОММУТАЦИИ В МДП-БИС В микросхемах на МДП-транзисторах в качестве элементов коммутации используют высоколегированные диффузионные шины с низкими значениями сопротивления. Эти шины изолированы от объема полупроводниковой подложки обратносмещенным р-п переходом (рис. 3.43), а сверху покрыты изолирующей пленкой Si02, по поверхности которой прокладываются металлические проводя- 5 Зак. 918 (>3 Гикоомия МПП У и в полупроводниковой ворГми МДП-транзисторах с алюминиевыми зат-. мутации алюминиевая шина ком-
ПДП БИС Тугоплабние метомы  Рис. 3,44. Предельные возможности различных систем ТИг^п^ТмиТ ° элементов коммутации и затворов МДП-микросхем Силициды но полинремнии Предел для алюминия /! тпЬанный алюминий Чистый алюминий Чистый нагреё обрадотна на напыли-алюминии *падлажыи тельнт oinZZni 0,5 . 1 . . п'Лип1ш P-PiB , неснольномишеней W,: алюминии металлы (цстанабон} : Системы длагородньк или тугоплаёнил мегтюллав магнетроннае распыле-ние мишени Л Ширина somSapoS, ним Ширина npaSBdHUKoS,MHM шие дорожки (алюминий) в направлении, перпендикулярном расположению диффузионных шин. При использовании в качестве затворов поликристаллического кремния создается еще один (третий) уровень разводки. Для этого проводящие дорожки формируют при диффузионном или ионном легировании пленок поликремния. Удельное поверхностное сопротивление токоведущих сигнальных шин в МДП БИС имеет следующее значение: для алюминиевых шин ps0,05 Ом/П, для диффузионных шин р * -типа ps50 Ом/П, для диффузионных шин и^-типа pslO Ом/П, для шин из поликристаллического кремния ps40 Ом/П. По мс/ре того как минимальный размер элементов СБИС уменьшается до микрометра и менее, возникают новые требования к материалам и технологии создания разводки. Предназначенные для создания затворов и соединяющих их шин разводки пленки поликристаллического кремния обладают существенными преимуществами: низкие пороговое напряжение и контактное сопротивление с шинами других уровней разводки и с монокристаллическим кремнием; плавное перекрытие крутых ступенек; стабильность границ раздела ППК - окисел, ППК - кремний; высокая разрешающая способность литографических процессов. Однако при ширине дорожек менее 2 мкм высокое сопротивление ограничивает применение пленок ППК. Усилия по снижению Ps ППК методами легирования и термических рекристаллизацион-ных обработок не дали существенных результатов: ps не удалось снизить больше чем до 10..,20 Ом/П. f, Уменьшить сопротивление разводки можно, применив пленки тугоплавких металлов или их силицидов (рис. 3.44). Они имеют низкое поверхностное сопротивление; наносимые поверх пленок ПК (рис. 3.45), они играют роль шунта поликремниевой шины разводки. Металлические молибденовые или вольфрамовые шунты требуют нанесения защитного слоя, предотвращающего их от окисления. У вольфрамовых пленок при толщине 0,12 мкм ps l Ом/П. Поскольку химическое или иное травление пленок Мо и W - процесс сложный, а на заключительных этапах создания микросхем на МДП-транзисторах даже нежелательный, разработаны методы селективного осаждения этих материалов на поверхность пленок ПК. Силициды тугоплавких металлов привлекают к себе все большее внимание как материалы для соединительных проводников БИС и СБИС. Наиболее перспективны силицид молибдена и силицид вольфрама. Использованный для формирования затворов и разводки силицид молибдена MoSi2 при толщине пленки 0,3 мкм имеет Ps=3,5 Ом/П. Столь низкое удельное поверхностное сопротивление позволяет уменьшить задержку из-за распределенных сопротивлений и емкостей в линиях связи примерно в десять раз по сравнению с задержкой, свойственной приборам с поликремниевыми затворами и разводкой.  Глава Рис. 3.45. Коммутация в МДП БИС с использованием легироваииого поликремния (а) и поликремния с шунтом из тугоплавких'переходных металлов (W, Мо) или их силицидов (б): /-кремниевая подложка: 2-пленка SiOj: 3-пленка полнкристаллического кремния; 4~ пленка переходного металла {или силицида)  ps = i5 Ом/а р%=2 Он/а б) При создании соединений между элементами БИС возникают' собственные требования. В первую очередь речь идет об устойчивости.к электромиграции при высоких плотностях тока, равномерном плавном перекрытии ступенек в слое диэлектрика, об устойчивости к коррозии и о возможности хорошей приварки проволочных выводов. Оценки показывают, что при размерах эдементов, характерных для сегодняшнего дня, алюминиевые сплавы обладают преимушест-вами. Однако с уменьшением ширины дорожек до 1 мкм сушест-венную роль начинают играть три недостатка: ограниченные возможности алюминия с точки зрения пропускания через него тока, его недостаточно стабильный контакт с кремнием и его склонность к коррозии (см. также § 2.10). Любая возможная замена алюминия имеет свои недостатки,: но вольфрам обладает наиболее перспективным сочетанием свойств.! Вольфрам, по-видимому, будет наиболее перспективным металлом для создания разводки. Ни одно рассмотрение перспективной технологии создания разводки не будет полным, если не уделить внимание диэлектрикам, разделяющим слои разводки. Требования к этим диэлектрикам сформулировать легко: пленки не должны иметь значительных , механических напряжений и должны быть устойчивыми к растрески-1 ванию, они должны содержать минимум дефектов, обеспечивать гладкую поверхность. К методам сглаживания рельефа диэлектрических пленок, наносимых на металлические дорожки, проявляется значительный интерес. Предпочтение отдается низким температурам осаждения и отжига. Пленка должна быть барьером для переноса примесей и обладать низкой диэлектрической постоянной. В основном в качестве межслойных диэлектриков применяют пленки Si02, осажденные из газовой фазы и из плазмы, а также пленки нитрида кремния, фосфоросиликатного и борофосфоросили-катных стекол. К этому следует добавить полиимидные пленки, особенно с учетом того, что они позволяют улучшить планарность. 132 КОНСТРУКЦИИ ЭЛЕМЕНТОВ ИПОЛЯРНО-ПОЛЕВЫХ ПОЛУПРОВОДНИКОВЫХ МИКРОСХЕМ 4.1. КЛАССИФИКАЦИЯ ОДНОКРИСТАЛЬНЫХ БИПОЛЯРНО-ПОЛЕВЫХ МИКРОСХЕМ Микросхемы, содержащие интегрированные на одном кристалле биполярные и полевые транзисторы, по конструктивно-технологическому исполнению классифицируют на содержащие биполярные и полевые с управляющим р-п переходом транзисторы, содержащие биполярные и полевые с изолированным затвором транзисторы и на содержащие биполярные и полевые с управляющим р-п переходом и полевые с изолированным затвором транзисторы. По функциональному назначению они подразделяются на аналоговые и логические; в аналоговых микросхемах, в свою очередь, можно выделить операционные усилители, негатроны, усилительные каскады БИС и СБИС, повторители напряжения, аналоговые мультиплексоры, компараторы, схемы выборки и хранения и др. Уже первые работоспособные аналоговые микросхемы, изготовленные по биполярно-полевой технологии, непременно превосходили те, что созданы на основе только биполярных приборов. Наиболее широкое распространение к настоящему времени получили микросхемы с биполярными и полевыми с управляющим переходом транзисторами, так как они могут быть изготовлены на основе хорошо отработанных и освоенных технологических вариантов, например планарно-эпитаксиальной технологии. Естественно, что необходимость оптимизации физико-топологических моделей как билолярного, так и полевого транзисторов, пригодных для формирования их в одном кристалле с целью получения необходимых электрофизических параметров микросхем, приводит или к некоторому усложнению технологии или к снижению выхода годных. 4.2. ПОЛЕВЫЕ ТРАНЗИСТОРЫ С УПРАВЛЯЮЩИМ р-п ПЕРЕХОДОМ Интегральные микросхемы на основе одних только полевых транзисторов с управляющим р-п переходом (см. § 1.2, рис. 1.13) в настоящее время не выпускаются. В последнее десятилетие такие транзисторы стали одним из основных элементов полупроводниковых микросхем, использующихся в сочетании с биполярными транзисторами в одном кристалле. На рис. 4.1 показана конструкция полевого транзистора с управляющим р-п переходом (ПТУП) и каналом р-типа, совместимая с технологией изготовления микросхем на биполярных транзис-то]>ах п'* -р- -типа. 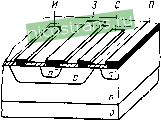 Рис, 4,1. Структура падевого транзистора с упоав-ляюшим р-п переходом, совместимая с изготовлением микросхемы на биполярных транзисторах по планарно-эпитаксиальной технологии { Нанал 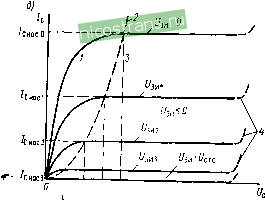 ОШненный слой Рис. 4.2. Структура (а...г) и выходные характеристики (д) полевого транзистора с управляющим р-п переходом и каналом п-типа; / - крутая лиггсйная область; 2~ граница перекрытия канала; 3- пологая область насыщения; 4~ область пробоя На рис. 4.2, а показана структура полевого транзистора с управляющим р-п перехсом и каналом п-типа, совместимая с п^-р-п-биполярнон технологией. Области канала п-типа и высоколегированные области п+ и р+, являющиеся электродами полевого транзистора, получены диффузией примесей. Участок управляемой проводимости или канал, находящийся между истоком и стоком, располагается под областью затвора. Подложку рассматривают как самостоятельный электрод. В структуре ПТУП и каналом п-типа можно указать следующие переходы: затвор-исток ЗИ, затвор-сток ЗС, подложка-исток ПИ, подложка-сток ПС. Все эти переходы при работе полевого транзистора должны быть смещены в обратном направлении, откуда следует, что напряжение на затворе относительно истока должно 134 бь1ть1уррщ1ательвьш, а напряжение на стоке относительно истока - положительным. В дискретных ПТУП подложка, как правило, технологически соединяется с верхним низкоомным затвором, а в интегральных полупроводниковых схемах - с точкой, имеющей наименьший потенциал, поскольку является общей частью и для остальной схемы. Для полевого транзистора с управляющим р-п переходом и каналом р-типа знаки напряжений на внешних электродах необходимо заменить на противоположные, а подложку соединить с точкой с наибольшим потенциалом. Наличие разнополярных напряжений - существенный недостаток схем, выполненных с применением ПТУП. Принцип действия полевого транзистора с управляющим р-п переходом и каналом п-типа поясняет рис. 4.2, б...г. Поскольку потенциалы на электродах транзистора измеряются относительно истока, будем считать его заземленным. При нулевых иапряжениях на затворе и стоке ток через канал не проходит. Тад-щины обедненных слоев (областей пространственных зарядов) в этом случае минимальны и определяются контактной разностью потенциалов между р- и п-облас-тями. Если на затвор транзистора подается отрицательное напряжение, то обедненный слой проникает в глубь канала, сужая сечение той его части, в которой находятся свободные (подвижные) носители заряда. И хотя физические размеры структуры остаются неизменными, сечение проводящей части канала регулируется напряжением, приложенным к затвору. Таким образом, изменяя уровень отрицательного напряжения на затворе, можно управлять проводимостью канала между его истоком и стоком. Максимальная проводимость достигается при напряжении Uj=0, так как в этом случае сечение проводящей части канала максимально. При некотором значении напряжения на затворе обедненный слой проник;1ет на всю толщу канала, полностью перекрывая его, что приводит к падению проводимости до нуля. Напряжение 6/34, при котором наступает этот эффект, называется напряжением отсечки и обозначается Соте. Проводимость канала остается равной нулю, если \U3\>\Uo,c\- Поскольку выражение полностью перекрытый канал не содержит в себе количественного критерия, Umc условно определяется как напряжение на затворе (при заданном напряжении (У^и. при котором ток стока имеет определенное значение - обычно 1 или 10 мкА). При приложении положительного напряжения к стоку и при 1/=0 по каналу потечет ток. обусловленный основными носителями заряда (в данном случае электронами). Ток стока /с сначала растет пропорционально росту напряжения (/си-На выходных характеристиках (рис. 4.2, d) этому случаю соответствует линейная область. Когда напряжение t/си по величине сравнимо или больше 6отс, выходные характеристики становятся нелинейными. Это объясняется тем, что t/си увеличивает разности потенциалов между каналом и затвором, что в свою очередь увеличивает толщины обедненных слоев. Толщина обедненных слоев максимальна у стока и минимальна у истока. При некотором напряжении на стоке обедненные слои смыкаются вблизи него и в результате наступает момент, называемый перекрытием канала (рис. 4.2, в). Дальнейшее увеличение напряжения не приводит к росту тока /(-, а лишь увеличивает напряженность поля в обедненном слое. При этом точка смыкания обедненных слоев смещается в сторону истока. В узкой проводящей области вблизи стока плотность тока и электрическое поле велики; явления переноса носителей подобны инжекции носителей эмиттером биполярного транзистора в обедненную область обратносмещенного коллекторного перехода. Поскольку перекрытие канала при некотором Uq приводит не к отсечке тока, а только лишь к отсечке его приращении, удобнее это напряжение называть напряжением насыщения У„ас (при и^ц=0). После наступления насыщения ток не зависит от напряжения Uq, но остается зависимым от напряжения и^ц. При одновременном приложении напряжений затвора и стока насыщение тока стока наступает при различных напряжениях на стоке: чем больше запирающее напряжение, тем меньше напряжение на стоке, соответствующее насыщению тока [q. На семействе полных выходных характеристик, показанных на рис. 4.2, д, можно выделить три области: (крутую) линейную , (пологую) насыщения и область пробоя, в которой ток Iq резко возрастает при небольших увеличениях напряжения t/си- При увеличении напряжения U может произойти пробой соответствующего перехода, однако он не выводит из строя транзистор, если при этом мощность рассеяния иа нем не будет превышать максимально допустимую. После возвращения в нормальный рабочий режим транзистор восстанавливает свою работоспособность. Это свойство полевых транзисторов с управляющим р-п переходом дает им большое преимущество перед транзисторами МДП-типа, так как у последних возникновение пробоя в цепи затвора приводит к выходу их из строя. При положительном напряжении (Узц ток Iq увеличивается незначительно, так как изменение смещения в прямом направлении несущественно влияет на ширину обедненного слоя. Выше отмечалось, что если переход смещен в прямом направлении, то для работы транзистора требуется большой ток затвора /3. При отрицательном напряжении входное сопротивление R, составляет величины порядка 10... lot Ом. Роль И значение полевых транзисторов с управляющим р-п переходом в полупроводниковых микросхемах, содержащих в одном кристалле и биполярные транзисторы, особенно заметны при создании усилительных каскадов. Сочетание биполярного и полевого транзисторов в различных усилительных каскадах устраняет недостатки, свойственные каскадам, построенным исключительно на биполярных транзисторах. Хорошо известно, что биполярный транзистор обладает высокой крутизной передаточной характеристикой, но низким входным сопротивлением по сравнению с полевым транзистором. Простая схема (рис. 4.3) усилителя-инвертора, состоящего из полевого VT1 и биполярного VT2 транзисторов, позволяет устранить этот недостаток, сохранив положительные качества транзистора VT2. Работает данный усилитель следующим образом. Входной управляющий сигнал от источника t/3 отрицательной и положительной полярности, подаваемый на затвор VT1, вызывает соответствующее   Рис. 4.3. Схема биполярно-полевого усилителя-инвертора Рнс 4 4. Биполярно-полевой усилительный каскад без насыщения изменение тока стока полевого транзистора, пропорциональное его крутизне, и последующее изменение тока коллектора биполярного транзистора, пропорциональное его коэффициенту передачи тока (крутизне). Следовательно, результирующая крутизна такой схемы равна произведению крутизны полевого на крутизну биполярного транзисторов. Так как входной сигнал подается на затвор полевого транзистора, то дополнительно достигается и высокое входное сопротивление. Известно, что при больп)их токах базы биполярный транзистор входит в режим насыщения и становится неуправляемым. На рис. 4.4 изображена схема усилительного каскада, свободная от этого недостатка. В исходном состоянии полевой транзистор VTI закрыт положительным напряжением от источника электропитания (Ук,э-Когда напряжение на коллекторе биполярного транзистора вследствие увеличения входного тока станет равным напряжению на базе, транзистор VT2 должен войти в режим насыщения. Однако при этом откроется полевой транзистор, и часть входного тока через него потечет на землю. Это вызовет уменьшение коллекторного тока, потенциал коллектора VT2 (а также затвора VTI) повысится и полевой транзистор закроется. Таким образом, биполярный транзистор не входит в насыщение, и каскад стабильно работает в активном режиме. Известно, что для обеспечения высокого коэффициента передачи тока и граничной частоты усиления биполярного транзистора необходимо уменьшить толщину его активной базы. Однако это ведет к снижению его пробивного напряжения в схеме с общим . эмиттером и напряжения смыкания коллекторного и эмиттерного р-п переходов. Оптимальное сочетание перечисленных электрических характеристик достигается соединением биполярного и полевого транзисторов по каскодной схеме, изображенной на рис. 4.5. Введение в коллекторную цепь биполярного транзистора полевого транзистора, сопротивление канала которого возрастает с увеличением напряжения /к,Э. позволяет перераспределить это напряжение между р-п переходом коллектора и сопротивлением канала. Уже не все напряжение /э прикладывается к коллекторному переходу, VTI VT2 Выход VT2 Рис. 4.5. Биполярио-полевая каскодная схема с высоким напряжением пробоя Рис. 4.6. Симметричный оконечный усилительный каскад без переходных искажений который В ЭТОМ случае пробивается при большем питающем напряжении, чем в обычном биполярном транзисторе. Симметричные оконечные усилительные каскады, построенные на основе комплементарных биполярных п-р-п и р-и-р-транзисторов, в режиме линейного усиления обладают существенным недостатком - переходными искажениями. Этот недостаток обусловлен тем, что ток в нагрузке усилителя отсутствует до тех пор, пока напряжение эмиттер-база на одном из транзисторов не превысит приблизительно 0,6 В (для кремниевых транзисторов). Для исключения переходных искажений в таких усилительных каскадах предлагается использовать параллельное включение биполярных транзисторов н полевого транзистора с управляющим переходом, как это показано на рнс. 4.6. Биполярный р-п-р-транзистор VT2 и р-канальный полевой транзистор VT3 образуют единый трехэлектродный элемент. Транзистор VT3 работает как истоковый повторитель в диапазоне входного напряжения, при котором оба биполярных транзистора VT1 и VT2 закрыты. Следовательно, устраняются переходные искажения, свойственные симметричному каскаду на биполярных транзисторах, при сохранении экономичности его цепи питания. На основе этого принципа уже разработана интегральная микросхема повторителя Напряжения, содержащая на одном кристалле биполярные и счетверенные полевые транзисторы, благодаря наличию которых существенно возросла скорость нарастания сигнала. Из приведенных выше примеров создания усилительных каскадов полупроводниковых микросхем видно, что объединение биполярного и полевого транзисторов в одной микросхеме позволяет не только существенно улучшить ее электрические характеристики, но и расширить ее функциональные возможности. В схемотехническом отношении такие структуры позволяют в линейных микросхемах достичь существенного уменьшения входного статического тока смещения, повышенной скорости нарастания сигнала и большого вход-138 ного сопротивления. Улучшение примерно на порядок частотных характеристик является еще одним, в ряде случаев еще более важным преимуществом таких микросхем. Особенно ярко эти возможности видны на примере разработок интегральных полупроводниковых схем операционных усилителен (ОУ). Динамические характеристики операционных усилителей, изготовленных по чисто биполярной технологии, ограничены параметрами p-rt-p-транзисторов. Биполярно-полевая технология позволяет заменить их полевыми с р-каналом и тем самым существенно улучшить быстродействие ОУ. Применение полевых транзисторов во входных каскадах ОУ позволяет на несколько порядков снизить входной ток смещения, что приводит к улучшению точностных характеристик усилителя. Входной ток в полевом транзисторе с р-п переходом не превышает 10* А. Для схем операционных усилителей с частотной компенсацией скорость нарастания сигнала пропорциональна отношению статического тока смещения транзистора входного каскада к его крутизне. По сравнению с биполярными транзисторами токи смещения полевых транзисторов, необходимые для получения такой же крутизны, больше, поэтому применение полевых транзисторов обеспечивает значительное увеличение скорости нарастания выходного сигнала. В операционных усилителях с полевыми транзисторами на входе скорость нарастания выходного сигнала можно повысить примерно в 20 раз без увеличения полосы пропускания. Использование на одном кристалле наряду с биполярными полевых транзисторов позволило существенно расширить полосу пропускания, снизить уровень шумов, повысить скорость нарастания сигнала и входное сопротивление усилителя, схема которого представлена на рис. 4.7. Схема содержит дифференциальный входной каскад на полевых транзисторах с управляющим р-п переходом. Этот каскад выполнен на двух полевых транзисторах с согласованными параметрами, за которыми идет дифференциальный каскад на биполярных тран- VTiU -0 + tBbixoi ± lBbixad VT6
Рис. 4.7. Базовля схема операционного усилителя с би1, ирными и полевыми с управляющим р-п переходом транзисторами Рис. 4.8. Схема выходного каскада операционного усилителя с составным биполярно-полевым транзистором зисторах, обеспечивающий симметричную нагрузку с точки зрения токов смещения. Транзисторы VTI и VT2, как видно из рис. 4.7, используются для усиления входного сигнала, вторая же пара полевых транзисторов VT3 и VT4 обеспечивает одинаковые токи смещения на первых. На рис. 4.8 показан пример использования полевого транзистора в выходном каскаде операционного усилителя для повышения его устойчивости при работе на большие емкостные нагрузки. Транзисторы VT1 и VT2 образуют широкополосный составной биполярно-полевой транзистор. Здесь мы вновь встречаемся с универсальностью полевых приборов, о которой говорилось в § 3.1. Полевые транзисторы могут быть использованы и как активные и как пассивные нагрузочные элементы, что не осуществимо в микросхемах на биполярных транзисторах. В каждом конкретном случае совместного применения биполярного и полевого транзисторов в составе полупроводниковой микросхемы к каждому из них предъявляются свои специфические требования. 4.3. КОНСТРУКТИВНО-ТЕХНОЛОГИЧЕСКИЕ ВАРИАНТЫ ИСПОЛНЕНИЯ БИПОЛЯРНОГО И ПОЛЕВОГО ТРАНЗИСТОРОВ В ОДНОМ КРИСТАЛЛЕ При изготовлении биполярного и полевого транзисторов в одном i кристалле возникает та же проблема оптимизации характеристик и физико-топологических структур, которая обсуждалась в § 2.2 в *Связи с необходимостью оптимизации одновременно двух биполярных транзисторов п^-р-п- и р-и-р-типов, создаваемых в одном кристалле. Из описания принципа работы полевого транзистора с управляющим р-п переходом ясно, что одновременно обеспечить низкое напряжение отсечки и высокое напряжение пробоя р-п перехода затвор - исток полевого транзистора можно созданием тонкого и слаболегированного канала. Для обеспечения большого коэффициента передачи тока и высокой граничной частоты биполярного транзистора база также должна быть тонкой. Но при снижении степени легирования базы уменьшаются предельная частота усиления и напряжение прокола базы. Такая взаимосвязь конструктивно-технологических параметров Областей и электрических характеристик транзисторов определила один из возможных путей создания интегрированных биполярных и полевых с управляющим электродом структур - формирование активных областей транзисторов различных типов с различной толщиной и степенью их легирования. Один из вариантов такого рода структур, характеризующийся малым напряжением отсечки ПТУП, представлен на рис. 4.9. В данном случае уменьшение напряжения отсечки достигается за счет 140 п'-р-п-транзистар Ш^П-транзистор  Рис. 4.9. Структура, содержащая биполярный и V-ПТУП-транзистор: I- подложка кремния р-типа; 2- эпитаксиальный слой; 3- скрытый слой; 4- изолирующие области; 5- базовая область; в-- область канала р-типа; 7--У-о6разное углубление; 8- обласп амиттера; 9- область затвора; 10- п+-о6ласть контакта к кп лектору использования V-ПТУП. Технология изготовления данной структуры состоит из следующих этапов: в кремниевую подложку р-типа с эпитаксиальным слоем и-типа, содержавшую скрытый п'-слой и изолирующие диффузионные области р+-типа, проводится диффузия для формирования областей базы и канала р-типа. Затем с по-.мощью фотолитографии вскрывается окно в окисном слое и осуществляется химическое травление базовой области в структуре ПТУП для образования V-образного углубления. Подложка имеет кристаллографическую ориентацию (100). Далее проводится диффузия для формирования областей n-ima эмиттера, затвора и омического контакта коллектора. Этот конструктивно-технологический вариант изготовления микросхемы позволяет полностью совместить технологические операции формирования областей обоих типов транзисторов, но требует введения дополнительных операций фотолитографии и травления. Обеспечить более точную регулировку концентрации легирующей примеси в канале, а следовательно и напряжения отсечки, по сравнению с шффузионной технологией, можно с помощью ионного легирования. Применение ионного легирования позволяет изготовлять микросхемы, содержащие на одном кристалле высококачественные биполярные транзисторы и высококачественные полевые транзисторы с точно согласованными параметрами. Структура, содержащая такие транзисторы, представлена на рис. 4.10. В ней одна ионно-легированная область образует канал р-типа между областями истока и стока, вторая ионно-легированная область образует затворную область над этим каналом. Такая технология включает операции диффузии базы, истока и стока, а также эмиттера и омических контактов коллектора и затвора. На следующих этапах изготовления микросхемы готовая пластина с диффузионными областями дополняется областями канала и затвора, формируемыми методом ионного легирования. По данной технологии изготавливаются описанные в § 4.2 операционные усилители. Различие между структурой биполярный транзистор - ПТУП и структурой на основе обычной планарно-эпитаксиальной технологии заключается в наличии сформированного ионным легированием канала, заглубленного под поверхность полупроводникового материала в промежутке между областями истока и стока. В процессе 1 ... 4 5 6 7 8 9 10 ... 20 |
|||||||||||||||||||||||||||||